低温锡胶是一种合金熔点低于180℃的环氧型锡膏,由于低温合金主要为铋基合金,而铋基合金属特点就是富铋层的存在容易产生脆性断裂,跌落性能差,焊点可靠性低。而低温锡胶添加了环氧树脂等高分子材料,对焊点进行补强,增强焊点的抗跌落性能,同时树脂胶优良的电绝缘性能和防护性能,为封装基板提供高可靠性能。非常适用于薄型基板、非耐热性器件、高可靠器件的封装应用。锡胶是一种新型封装电子材料。

锡胶又称环氧锡膏,其独特的优势被广泛应用于 SMT 精密电子元件焊接、半导体封装、芯片封装、LED 芯片粘接封装、FPC 柔性产品、摄像头模组等精细焊接领域。福英达的锡胶产品是将球形度优异、粒度均匀、氧含量低、强度高的合金焊粉与无卤素环氧助焊剂结合制备而成的高强度焊接产品。在焊接和固化过程中只有极少量的溶剂挥发,焊接后不会形成焊球。焊粉熔化和收缩后,焊点通过冶金连接。助焊剂残留物成为热固胶,加强了焊点,起到了防腐蚀和绝缘的作用。福英达的锡胶产品具有免清洗、防腐蚀、高绝缘等特点,是一种新型电子封装材料。产品涵盖低温和中高温的多种合金,粒径涵盖 T4 ~ T10,适用于各种应用场合。
福英达的超微锡胶产品主要包括低温超微锡胶、中高温超微锡胶、Mini LED 专用锡胶和各向异性导电胶。


低温锡胶是一种合金熔点低于180℃的环氧型锡膏,由于低温合金主要为铋基合金,而铋基合金属特点就是富铋层的存在容易产生脆性断裂,跌落性能差,焊点可靠性低。而低温锡胶添加了环氧树脂等高分子材料,对焊点进行补强,增强焊点的抗跌落性能,同时树脂胶优良的电绝缘性能和防护性能,为封装基板提供高可靠性能。非常适用于薄型基板、非耐热性器件、高可靠器件的封装应用。锡胶是一种新型封装电子材料。
低 温 超 微 锡 胶 的 特 点 |
|
物 理 特 性 | |
| 颜色:浅灰色 |
| 粘度:L低、M中 |
| |
技 术 指 标 | |
卤素含量:无卤 J-STD-004B | 助焊剂类型:ROL1 |
坍塌试验:合格 J-STD-005 | 润湿性:合格 J-STD-005 |
铜板腐蚀性:合格 J-STD-004 | 残留物干燥度:合格 |
锡球测试:合格 J-STD-005 | 铬酸银纸测试:合格 J-STD-004 |
使 用 方 法 |
|
包 装 信 息 |
1. 包装 EFD针筒10g/5cc、30g/10cc包装,可按客户要求进行包装,运输时采用冰袋、泡沫箱+纸箱包装。 2. 运输储存 运输条件:冰袋冷藏运输 储存条件:收到后应尽快将其放进冰箱储存,建议储存温度为-20℃。温度过高会相应缩短其使用寿命,影响其特性 |
工 艺 | 合 金 组 成 | 粉 末 粒 径 | 焊 剂 类 型 | 清 洗 类 型 |
| 印刷 | SnBiAg | T6 (5-15μm) T7 (2-11μm) T8 (2-8μm) | 无卤素(Cl+Br<1500 ppm) | 免洗 / 水基清洗 |
| FL170 | T4(20-38μm) | 无卤素(Cl+Br<1500 ppm) | 免洗 / 水基清洗 | |
| 点胶 | SnBiAg |
| 无卤素(Cl+Br<1500 ppm) | 免洗 / 水基清洗 |
| FL170 | T4(20-38μm) | 无卤素(Cl+Br<1500 ppm) | 免洗 / 水基清洗 |
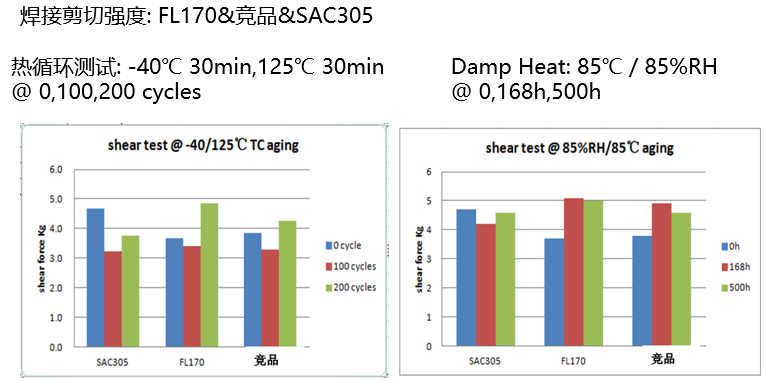






我们的工程师将很乐意解答你的问题,或者帮助您选择合适的焊料产品
