
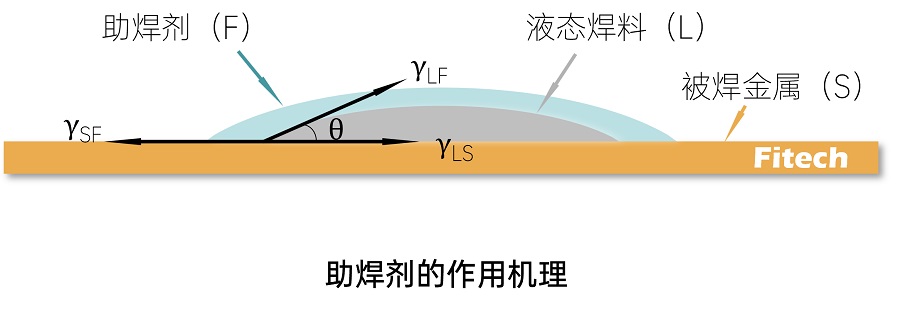
细间距助焊剂是在微电子与半导体生产、装配、封装时使用的助焊材料。适用于晶圆凸点焊接、芯片蒸镀焊接、BGA、SiP、CSP、MicroLED封装、模组集成电路等领域的高精密、高可靠封装。
环 氧 助 焊 胶 的 特 点 |
c 焊接后固化的环氧树脂可起到绝缘、防腐、增加可靠性; d 操作简单,可选择回焊炉、电热板、烘箱等; e 同底部填充胶、邦定胶等相兼容; f 机械强度高,相比松香基助焊剂,环氧树脂基助焊胶焊接后机械强度更高。 |
物 理 特 性 | |
| 颜色:乳白色 |
| 粘度:L低 |
| |
技 术 指 标 | |
卤素含量:Cl+Br<900 ppm J-STD-004B | 助焊剂类型:REL0 |
铜镜测试:合格 IPC-TM-650 2.3.32 | 润湿性:合格 J-STD-005 |
铜板腐蚀性:合格 J-STD-004 | 铬酸银纸测试:合格 J-STD-004 |
表面绝缘电阻:合格 JIS Z3197-2012 | |
使 用 方 法 |
|
包 装 信 息 |
1. 包装 罐装:50g/罐,宽口型塑胶(PE)瓶包装,并盖上内盖密封封装,送货时可用泡沫箱盛装。 2. 运输储存 运输条件:冰袋冷藏运输 储存条件:收到后应尽快将其放进冰箱储存,建议储存温度为-20±5℃。温度过高会相应缩短其使用寿命,影响其特性。 |
工 艺 | 载 体 | 卤 素 | 焊 剂 类 型 | 清 洗 类 型 |
| 印刷 | 环氧树脂 | Cl+Br<900 ppm | REL0 | 免洗 |
| 点胶 | Cl+Br<900 ppm | REL0 | 免洗 | |
| 喷射 | Cl+Br<900 ppm | REL0 | 免洗 |

我们的工程师将很乐意解答你的问题,或者帮助您选择合适的焊料产品
