超微锡膏
6号、7号、8号、9号、10号
“6号粉”、“7号粉”、“8号粉” 锡膏 / 锡胶;“9号粉”、“10号粉” 锡膏 / 锡胶 / 各向异性导电锡胶


6号、7号、8号、9号、10号
“6号粉”、“7号粉”、“8号粉” 锡膏 / 锡胶;“9号粉”、“10号粉” 锡膏 / 锡胶 / 各向异性导电锡胶

T6-T10
环氧树脂锡膏,焊点加固,绝缘性加强,适用微间距,工艺简化提升效率,包括规模商用的 6号粉、7号粉、8号粉,以及尖端应用9号和10号粉

T4-T6
金锡焊膏是目前市场上可靠性最高的微电子与半导体焊接材料之一。适用于军工领域、航空航天领域、医疗设备领域...

T4-T6
高温无铅二次回流锡膏、低温无铅二次回流锡膏与常规锡银铜锡膏可组合不同温度条件下二次回流解决方案,解决两次回流焊点可靠性不一致问题

T5-T9
水溶性锡膏(也称水洗锡膏)是一种用于电子元器件焊接的特殊类型的锡膏。与其他类型的锡膏不同,水溶性锡膏可以用纯水(去离子水)溶解和洗净...

T6-T9
通过锡膏喷印机将锡膏以喷印的方式,无接触地精确地分布到焊盘上的技术称为锡膏喷印...

-
细间距助焊剂是在微电子与半导体生产、装配、封装时使用的助焊材料。适用...

T4-T9
锡膏中金属合金及助焊剂成分各不相同,因此不同锡膏的焊接温度不同。深圳福英达工业技术有限公司按照焊接温度...

T4-T9
无铅锡膏是“电子无铅化” 的产物,指包含铅在内的六种有毒有害物质(汞(Hg)、镉(Cd)、六价铬(Cr)、铅(Pb)...
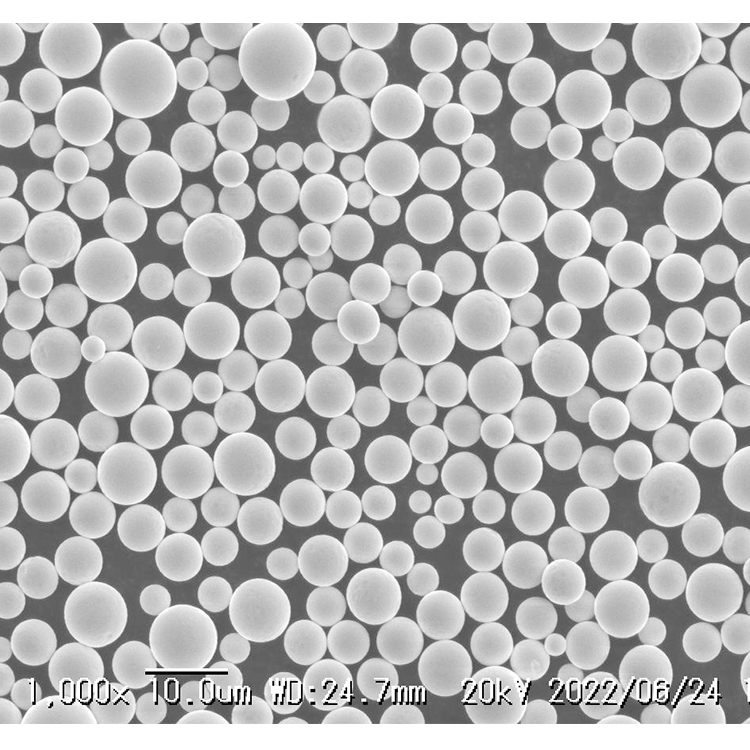
T6-T10
超微焊粉指合金粒径型号T6-T10的焊锡粉。随着微电子与半导体封装技术的发展,现在...

T3-T8
α焊料系列,是福英达公司为SiP系统级封装、Flip Chip芯片倒装等高密度、微型化封装开发的...

T2-T5
深圳福英达公司生产的普通SMT焊锡粉涵盖锡铅锡粉、锡铋锡粉、无铅无铋锡粉等各类合金,高中低各焊接温度...

T2-T10
深圳福英达工业技术有限公司有一支由高级工程师、青年科学家、硕士、学士等科研人员组成的研发团队,并组建了...

我们的工程师将很乐意解答你的问题,或者帮助您选择合适的焊料产品
Copyright ©2019 All Rights Reserved. 深圳市福英达工业技术有限公司 版权所有 粤ICP备2021131301