低温锡膏是一种合金熔点低于180℃,回流峰值温度不高于200℃的合金锡膏。一般应用在二次回流中第二次回流使用的锡膏,以及非耐热元器件、散热器件上的封装用锡膏。低温锡膏的合金成分铋为基础元素,添加其他金属的合金粉末。

锡膏中金属合金及助焊剂成分各不相同,因此不同锡膏的焊接温度不同。深圳福英达工业技术有限公司按照焊接温度的高低将锡膏产品分为高温、中高温、中温及低温锡膏。焊接温度高的锡膏往往强度也较高,适用于对焊接强度要求较高的焊接过程,以及二次回流的第一次回流;焊接温度低的锡膏往往对电路板的保护较好,适用于对温度较敏感的电路板和器件,以及二次回流焊接的第二次回流。
低温锡膏是一种合金熔点低于180℃,回流峰值温度不高于200℃的合金锡膏。一般应用在二次回流中第二次回流使用的锡膏,以及非耐热元器件、散热器件上的封装用锡膏。低温锡膏的合金成分铋为基础元素,添加其他金属的合金粉末。

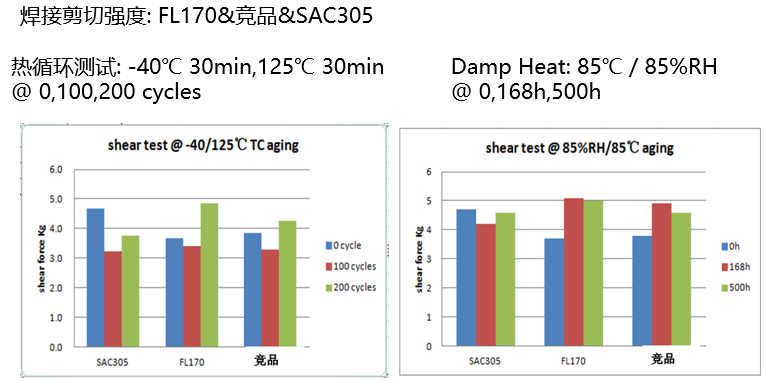


FTD-170 系列低温锡膏采用球形度好、粒度均匀、氧含量低、高强度的福英达FL170低温合金焊粉及优良零卤助焊剂配制的优质锡膏,焊接过程中很少溶剂挥发,焊接后无锡珠产生残留少,焊点强度大,为低温焊接的理想材料,非常适用于低温度元器件的贴片,其润湿性好,焊点光亮饱满。

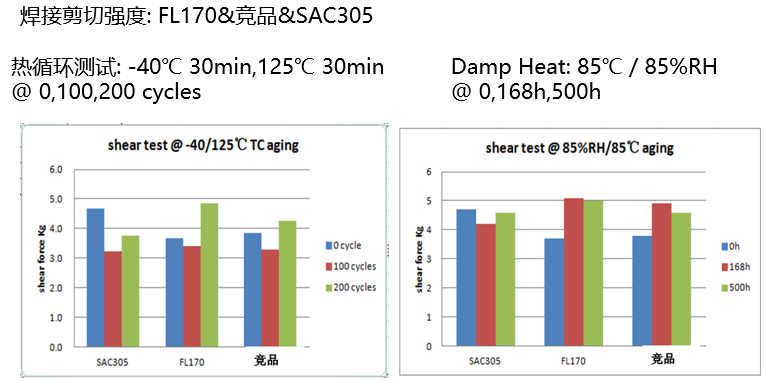

FTD-574 系列低温锡膏采用球形度好,粒度均匀,氧含量低的福英达 SnBiAg合金焊粉 及优良零卤助焊剂配制的优质锡膏,焊接过程中很少溶剂挥发,焊接后无锡珠产生残留少,为低温焊接的理想材料,非常适用于低温度元器件的贴片,其润湿性好,焊点光亮饱满。


我们的工程师将很乐意解答你的问题,或者帮助您选择合适的焊料产品
Copyright ©2019 All Rights Reserved. 深圳市福英达工业技术有限公司 版权所有 粤ICP备2021131301
