高温无铅-全球焊料界的世界梦
高温无铅-全球焊料界的世界梦
电子元器件,特别是功率元件,如IGBT等大电流高发热的元器件,内部电路连接一直是由高熔点焊料合金(SnPb95Ag2.5)925合金来完成的,该合金具有300度左右的熔点,元器件内部用此合金焊料连接后,可以使该元器件与线路板的组装连接时,焊点可以承受住常规的无铅焊料,如SAC305、SAC105、SnSb10等的回流最高温度,不出现焊点重熔、可靠性降低的极端破坏状况,由此925合金是一种成熟可靠的元器件内部焊接材料。
随着全球电子封装行业无铅化浪潮的影响,对元器件的内部连接焊料也提出了无铅化的要求,欧盟关于这部分的豁免条约的限期越来越近,使得全球焊料界关于高温合金的使用受到了必须无铅化的巨大压力,寻求一种无铅但具有高熔点的合金,成而替代现有的925合金,成为全球焊料界的世界梦。锡基焊料合金由于其相图所限制,已有的理想二元锡基合金,但可以满足该要求的只有金锡合金,Au80Sn20,该合金是共晶合金,仅具有280°C的熔点,可以替代925合金使用,但昂贵的成本使得该合金只能用于部分高端光电元器件和军工用品。各国焊料界科学家和工程师从另外的途径想方设法解决此世界难题,主要有以下几种替代方法:
①烧结银浆
银的熔点是961°C,但在微米和纳米状态下,和树脂混合的浆料可以在250°C熔化并重新结成块状,成而在二次加热时,熔点回到961°C,这样就可以达到高熔点无铅焊料的要求。烧结银浆具有高的导热和导电性能,可以在加压或者无加压的条件下实现元器件的焊接,形成高可靠性的焊点,已经商品化并在工业界得到启用和认可,缺点是成本较高,与传统925焊料不是一个价格数等量,使全面替代受到影响。
②烧结铜浆
烧结铜浆的原理类似烧结银浆,也是用纳米级铜粉把铜的熔点从1083°C降到了250°C左右,浆料烧结成铜块焊点,再次熔融的温度又回到了1083°C,实现可熔点无铅焊点的目的。但由于铜粉易氧化等技术难点,目前烧结铜浆仍处于研发攻关阶段。
③瞬间液化固化焊料
近10多年来,瞬间液化固化焊料得到了全球焊料界的关注,并投入了大量资源进行研发攻关。这种焊料的特点是利用锡对铜及其化学物的腐蚀性强的原理,将焊料熔融过程当作一个微冶金过程,使锡合金中如SAC305中加入铜纳米和微米颗粒,或者Cu6Sn5纳米和微米颗粒。在SAC305的熔融状态下,与加入的这些铜粉和铜化合物粉未实现一个微冶金过程,形成以铜化合物Cu6Sn5为主成份的混合焊点。由于铜化合物Cu6Sn5的熔点是420°C,这就使这种混合物焊点的再熔温度已经不是SAC305的217°C,可以达到300°C左右,甚至接近400°C。由这种混合焊料形成的元器件内部焊点完全可以满足线路板组装的焊料SAC305等二次回流峰值温度要求。
理想很丰满,现实很骨感。这种微冶金的理想状态,吸引了美、日、德、中各国科学家10多年的潜心追求,但由于微冶金的状态控制,铜粉的化学反应状况等因素的影响,目前也没有投入工业化的应用,仍在研发过程中。
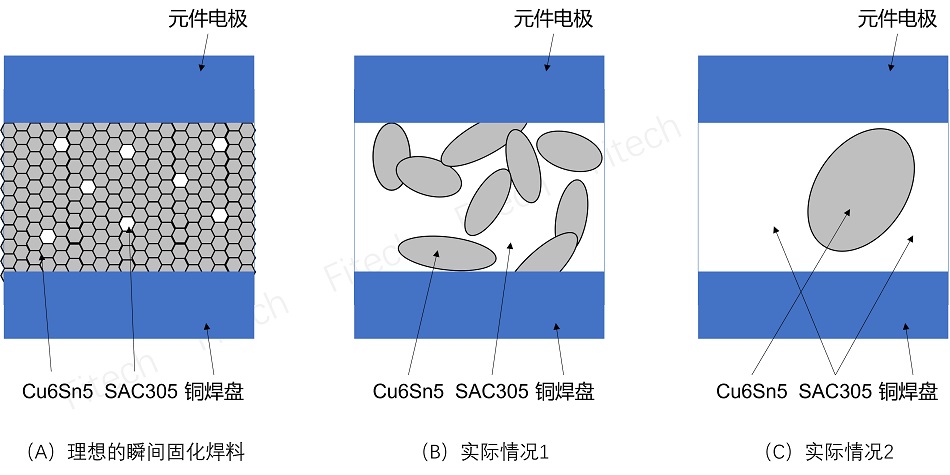
深圳市福英达工业技术有限公司作为全球领先的超微焊料生产制造商,经过我司科学家和应用工程师的大量研发及应用实践,合理推出了应用常规的SAC305替代925的无铅二次回流方案。这种方案的特点是第二次回流采用SAC305焊料用于原器件的内部焊点焊料,使得成熟的SAC305焊料可以满足元器件封装工艺和焊点的高导热导电性能,也具有实用性和成熟的封装工艺。在元器件、在线路板上封装后的二次回流工艺中,建议采用深圳市福英达工业技术有限公司的中国专利焊料FL200来实现。该焊料最高回流温度<200度,在已封装的元器件中SAC305焊料熔点217°C以下,不会影响元器件的可靠性,而这种低温焊料可具有SAC305 80%-90%的剪切力,接近的抗跌落性能和可靠性性能。已经得到全球焊料界的应用试验结果证明。正面强攻不行则侧面突破。深圳市福英达工业技术有限公司的降温二次回流方案,为实现全球焊料界的高温无铅世界梦提出了另一条途径。










 返回列表
返回列表



