焊点的失效模式有哪些 (5)

https://www.szfitech.com/
焊点的失效模式有哪些 (5)
之前的文章介绍了晶界滑动,焊料晶粒生长和取向,铅污染和IMC界面空洞对焊点的影响。空洞是导致焊点失效的直接原因之一。研究发现铜焊盘的晶粒大小同样对焊点可靠性有影响,反映在铜晶粒大小会影响焊盘界面空洞生长速率。空洞积聚成为裂纹并导致焊点断裂。本文会介绍铜焊盘晶粒大小对焊点的影响。
Cu3Sn/Cu界面处的空洞大量分布并削弱焊点机械性能并影响跌落性能,正如前一篇文章所解释那样。为了验证铜焊盘晶粒大小对Cu3Sn/Cu界面的空洞生长的影响,Li et al. (2015)将ED CCL板在150°C下退火1000小时,通过测量后发现退火后再回流的ED CCL板的晶粒尺寸显著增大。在进行老化测试后,观察发现退火的ED CCL板的空洞明显少于未退火,也就是说铜焊盘晶粒大小对空洞形成起到了显著作用。Li et al. 认为尽管退火后仍存在大量空位,但这些空位多数不能自由移动,不能有效积聚成为大面积分布的空洞。因此保持较大的铜晶粒大小对减少空洞起到积极作用。
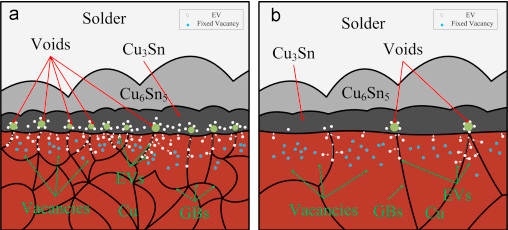
图1: 小的铜晶粒尺寸(a)比大的铜晶粒尺寸(b)更容易造成空洞,白色圆形是有效空位,蓝色圆形是固定空位 (Li et al., 2015)。
空洞的出现正是因为Sn和Cu原子扩散速率不平衡,因而导致了IMC内部出现空位。而铜焊盘晶粒大小影响着原子扩散速率。小的晶粒存在更多的晶界,这为原子扩散提供通道,从而形成更多的空位并在晶界附近积聚成为空洞。
参考文献
Li, H.L., An, R., Wang, C.Q., Tian, Y.H., & Jiang, Z. (2015), “Effect of Cu grain size on the voiding propensity at the interface of SnAgCu/Cu solder joints”, Materials Letters, vol.144, pp.97-99.









 返回列表
返回列表



