无铅锡膏电迁移对焊点可靠性的影响

https://www.szfitech.com/
无铅锡膏电迁移对焊点可靠性的影响
随着电子设备需求的增加和日趋的小型化,电迁移不仅对集成电路的可靠性提出了挑战,而且对电子封装的可靠性也提出了挑战。电迁移是影响锡膏焊点可靠性的因素之一。在电子设备使用时会产生电流应力在锡膏焊点处形成一定的电流密度,且随着I/O数量越来越多,电流密度也随之加大。电流密度是原子的迁移和金属间化合物生长的驱动力。随着时间推移,持续的电流应力可能会导致开路问题。
电迁移是由移动电子的动量转移引起的金属离子的扩散,电迁移发生条件是元件存在阳极和阴极。在电流应力作用下,互连焊点中的定向原子传输加速了UBM消耗和IMC层的不对称生长,并导致空隙、裂纹等缺陷。无铅锡膏容易出现电迁移,是因为无铅锡膏熔点较低导致较高的扩散率。快速的电迁移会导致焊点失效。AbdelAziz et al. (2021)测试了SAC305锡膏焊点的电阻的变化,发现在300多小时的时候电阻率迅速上升,意味着电迁移的发生 (图1)。并且焊点裂纹和空洞也随着时间变化。
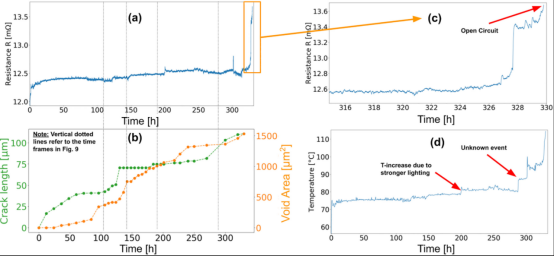
图1. SAC305锡膏焊点电阻测试结果,电流=5A (AbdelAziz et al., 2021)。
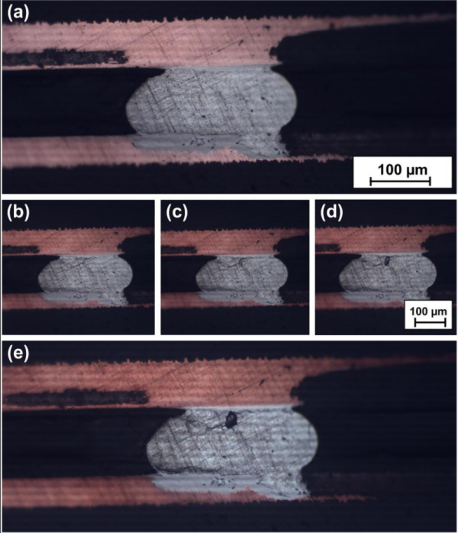
图2. SAC305锡膏焊点不同时间下的微观剖面图, (a) 0, (b) 102, (c) 139, (d) 171 and (e) 276 h (AbdelAziz et al., 2021)。
从图2可以看到,随着时间发展,SAC305锡膏焊点顶部和底部左下角出现了裂纹,且在焊点上方出现了空洞(黑色区域)。
类似的,Zuo et al. (2015)对共晶SnBi锡膏的电迁移测试,发现在电和热应力耦合作用测试后期,高电流密度造成电迁移,改变了由质量传输引起的界面力学,加快生成金属间化合物,并导致了最终的焊点失效。Zuo et al.实验结果显示在260小时电热耦合应力作用后,焊点出现了明显的空洞和棒状铋挤压(extrusions) (图3)。 裂纹已经进一步发展,并且Cu-Sn金属间化合物厚度越来越大,呈现出和时间的正相关关系。
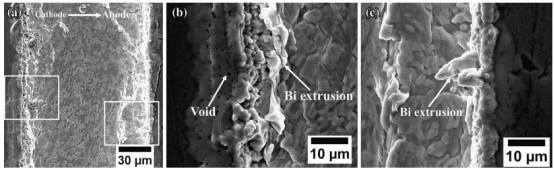
图3. SnBi58锡膏在电流密度2x103A/cm2和热循环状态下测试260小时后的SEM图;(a)阴极,(b)阳极 (Zuo et al., 2015)。
深圳市福英达工业技术有限公司致力于生成高可靠性超微锡膏产品,能够根据客户要求对锡膏参数进行调整。欢迎咨询了解。
参考文献
AbdelAziz, M., Xu, D.E., Wang, G.T., & Mayer, M. (2021), “Electromigration in solder joints: A cross-sectioned model system for real-time observation”, Microelectronics Reliability, vol.119.
Zuo, Y., Ma, L.M., Liu, S.H., Shu, Y.T., & Guo, F. (2013), “Evolution of Microstructure Across Eutectic Sn-Bi Solder Joints Under Simultaneous Thermal Cycling and Current Stressing”, Journal of Electronic Materials, vol.44.









 返回列表
返回列表



