无铅锡膏的基础知识百科 (4)_福英达焊锡膏

无铅锡膏的基础知识百科 (4)_福英达焊锡膏
封装厂家对焊接的要求是在回流焊完成后能够产生了形状均匀饱满的焊点,且需要满足规定的可靠性要求,如导热导电性能和机械强度。无铅锡膏焊点的形状对其可靠性有很大的影响,因此判断焊接是否出现缺陷首先可以通过观察焊点外观来确定。很多的因素会导致无铅锡膏焊点形状不良。
1. 焊盘清洗
水溶性无铅锡膏的活化剂成分在焊接后会产生酸性残留物,如果不及时去除会对焊点产生腐蚀作用。市面主常见的清洗工艺有水基清洗和半水基清洗,水基清洗由于清洗性优秀应用更多。可以将线路板进行浸泡、喷淋或超声波处理来达到清洗目的,最后再用25-60℃去离子水冲洗干净。也有一种免洗型无铅锡膏,活性稍弱但是焊后可以免清洗。厂家可以根据实际封装要求选择是否清洗。
2. 无铅焊点形状缺陷及影响
在完成焊接后,焊点底部连接着基板焊盘而顶部连接着元器件。焊点的外观通常是球体形状。形状的不同对性能的影响也不一致。通过垂直剖面图可以测量无铅焊点的宽度和高度。封装行业对无铅锡膏焊点的宽高比有要求,一般规定焊点的宽高比在1.3-1.5之间。合适的宽高比能够使焊点避免阻焊的损伤。
2.1 少锡和多锡问题
锡膏量对焊点形状的影响是最直接的。比如会出现锡膏量过少的问题。焊盘上的锡量过少会导致焊点强度不足。少锡发生的原因可能是焊盘或钢网有杂质附着,导致印刷时接触面积不够。也可能是无铅锡膏放置太久导致粘度增大,从而印刷时无法通过网孔造成锡量偏少。另外一种情况是多锡现象。如果钢网开孔和厚度偏大,则容易导致多锡。锡量过多会导致相邻锡膏点出现桥连现象,在间距小的焊盘上尤为明显。
2.2 锡膏坍塌和桥连
坍塌的成因有很多,包括锡量大,钢网脱模性差和锡膏粘度低等。如果锡量太大,在熔融流动时极易造成坍塌问题,并且还会与相邻焊点发生桥连。钢网尺寸不符和粗糙度不良会导致脱模性差,从而导致坍塌和桥连。此外,无铅锡膏粘度小意味着流动性更好,其保持形态的能力也就更弱,印刷后容易坍塌且加热后会向外扩散导致桥连。还有一些原因如印刷压力大,贴装偏移和锡膏合金颗粒细小也会造成坍塌和桥连。锡膏桥连会对电路造成很大的影响,主要体现在焊点之间短路。

图1. 焊接桥连现象。
2.3 焊点旁出现大量锡珠
锡膏被氧化和焊盘表面有杂质都会导致细小的锡珠的形成,从而影响焊接可靠性。粒径小的焊粉更易被氧化,形成锡珠的概率更大。锡珠的生成也和助焊剂活性差有关,较低的活性不能有效还原焊盘氧化层,从而可焊性差。此外,回流炉温度上升过快会加速助焊剂溶剂蒸发,焊料颗粒会随之飞溅出来形成小锡珠。锡膏未充分回温就回流加热也会导致飞溅形成锡珠。
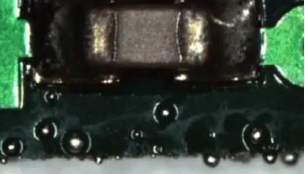
图2. 焊接界面周围出现锡珠。
深圳市福英达工业技术有限公司是一家全球领先的微电子与半导体封装材料方案提供商。福英达锡膏,锡胶等产品润湿效果好,粉末颗粒均匀,焊后可靠性强。欢迎进入官网了解更多信息。









 返回列表
返回列表



