甲酸气氛制备凸点_无助焊剂焊接-福英达焊锡膏

甲酸气氛制备凸点_无助焊剂焊接-福英达焊锡膏
众所周知无铅焊料需要借助助焊剂辅助才能实现更好的焊接效果。助焊剂可以去除焊料和焊盘表面氧化物和改善表面张力,使焊料能够更好的润湿焊盘。但是助焊剂分解不充分容易在焊点附近留下酸性残留物,从而影响电子元件的可靠性。随着业界对焊料认知的加深,一种不借助助焊剂的焊接方式呼之欲出。方法是在焊接时通入甲酸气氛保护。加热情况下甲酸气氛可以起到还原氧化物,改善润湿性的效果。
1. 甲酸还原氧化物原理
由于目前焊料以Sn为主,因此容易被氧化成为SnO和SnO2。甲酸能很好得与SnO和SnO2反应生成Sn(HCOO)2,并在150℃情况下将Sn(HCOO)2还原为Sn。

2. 甲酸气氛焊接实验
为了验证在甲酸气氛下不采用助焊剂焊接的可行性,He等人使用了Sn42Bi58,SAC305和Sn95Sb5焊料球分别在铜焊盘和镀镍铜焊盘上进行微凸点制备实验。Sn42Bi58,SAC305和Sn95Sb5的峰值焊接温度分别为200℃,250℃和275℃。微凸点随后在150℃下进行老化。甲酸焊接示意图如图1所示。
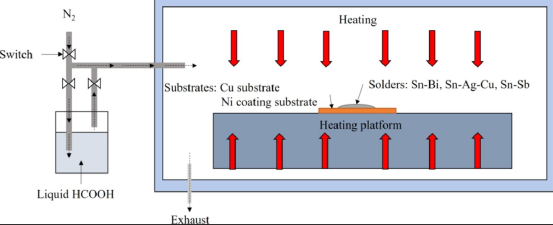
图1. 甲酸气氛下焊接的示意图。
表1. 实验采用的五种焊接加热条件。

3. 实验结果
3.1 焊料和基板的接触角
焊料与基板的接触角越小意味着焊料润湿性更优秀。Sn42Bi焊料在甲酸保护下焊接时的接触角要比使用助焊剂焊接的接触角更小。而SAC305和Sn95Sb5在助焊剂辅助下焊接时能得到更良好的接触角。总体而言,甲酸气氛下焊接和借助助焊剂焊接得到的接触角相差不大。
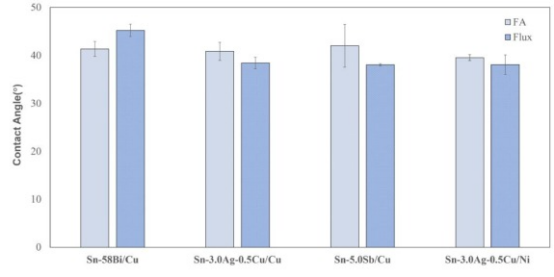
图2. 焊料采用甲酸气氛/助焊剂焊接后的润湿角 (升温速度: 2.5℃/s,预热时间1min), Sn42Bi58: 预热温度120℃;SAC305和Sn95Sb5: 预热温度160℃。
3.2 预热对甲酸气氛焊接的影响
如果加热速度,峰值温度和峰值时间均一致,SAC305在160℃下预热10分钟时,焊料与基板的接触角最小。而在160℃下预热1分钟时接触角最大。预热时间长能让甲酸有更充足时间与焊料和焊盘反应,更好得去除氧化物。此外,接触角也与预热温度有关,更高的预热温度能加速甲酸与氧化物反应。
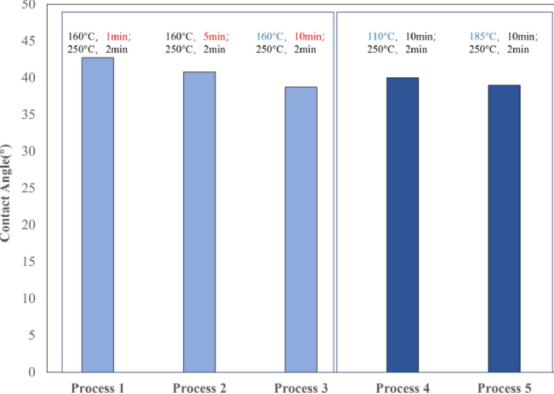
图3. 预热对甲酸气氛焊接接触角的影响。
3.3 金属间化合物
为了研究甲酸气氛焊接产生的金属间化合物(IMC)成分,He等人观察了SAC305焊点的微观结构。He等人发现甲酸气氛和助焊剂辅助焊接后生成的SAC305焊点的IMC都为Cu6Sn5,且焊点老化后也都形成了Cu3Sn。此外,总的IMC厚度相差不大。
为了满足封装界对焊料的需求,深圳市福英达投入了大量人力物力进行焊锡粉和焊锡膏的研发和生产。福英达的焊锡膏粘度稳定,板上时间长,润湿性优秀,能够满足客户对高焊接标准的要求。欢迎客户与我们合作。


4. 参考文献
He, S.L., Bi, Y.H., Shen, Y.A., Chen, Z.K., Gao, Y., Hu, C.A & Nishikawa, H. Contact angle analysis and intermetallic compounds formation between solders and substrates under formic acid atmosphere. Journal of Advanced Joining Processes, vol. 6.









 返回列表
返回列表



