LED封装的可靠性与空洞的联系-深圳市福英达

LED封装的可靠性与空洞的联系-深圳市福英达
日常生活中的显示设备如电视和电脑等几乎已经是每个家庭的必需品。显示产品的生产基本都离不开LED封装技术。为了实现更优秀的显示水平,LED显示屏上的灯珠数量势必要大幅度增加。为了让显示屏能容纳更多的LED芯片,芯片尺寸必然要进一步缩小。要做到这一点,则会使用到倒装技术。此外,倒装LED还能实现更小的热阻和更高的光效。
1. 倒装LED空洞实验
对于倒装LED,金锡焊料的使用非常普遍,但是高焊接温度对芯片的损伤的显而易见的。SAC锡膏也可用于倒装LED焊接的材料,与金锡焊料相比,其焊接温度更低。焊接过程如下图所示。

图1. 倒装LED焊接过程。
回流过程势必会使焊点中出现空洞,这会对焊点的强度会带来负面影响。为了弄清倒装LED焊接时的影响空洞形成的因素及空洞的影响,Liu等人采用固晶机将芯片键合到OSP铜焊盘的不同厚度的SAC305锡膏点上,在回流后测量焊点的空洞和强度。
2. 实验结果
2.1 空洞形成机制
一般情况下,空洞的形成有两种基本的形成机制。首先,在焊接过程中助焊剂溶剂因受热会挥发。部分空洞可以从熔融焊料中逃逸,而未能逃逸的气体则会在焊点中留下空洞。其次,芯片通常会被拾取和放置过在焊盘的锡膏上。当锡膏不足时,焊点会出现空洞。
2.2 倒装LED芯片空洞
下图显示了不同厚度锡膏所对应的导致LED焊点空洞率。当SAC305焊料层的厚度为20μm和30μm的时候,焊点的空洞百分比分别为46%和3%。显然,焊料体积对焊点空洞率有显著影响。随着锡膏量的增加,在焊点中没有出现大规模空洞,这表明在芯片放置过程中锡膏能与芯片均匀地接触。
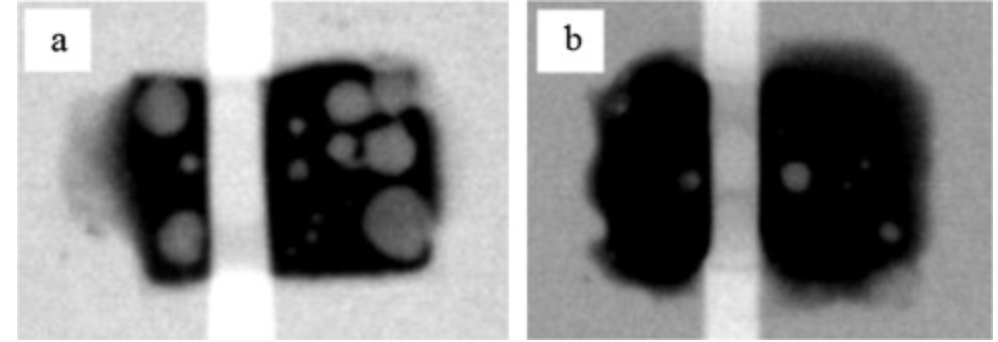
图2. 不同SAC305厚度对应的倒装LED焊点空洞率。a: 厚度20μm, b: 厚度30μm。
2.3 LED剪切强度
空洞的存在会影响IMC的形成,并会使得芯片和焊盘的连接面积小,这会对键合起到削弱作用。因此,当焊料层中空洞率降低时,LED封装的剪切强度会增加。此外,焊点受到的应力时会集中在空洞附近,并逐渐导致裂纹。

图3. 倒装LED焊点剪切力。1: 焊料厚度20μm, 2: 焊料厚度30μm。
2.4 LED热性能
芯片在通电情况下的热分布可以通过红外来检测。在100 mA电流下,对于焊料厚度更小(空洞率大)的LED芯片,芯片表面温度显然会更高。虽然理论上焊料厚度增加会阻碍热传导并使芯片温度更高,但是在这测试条件下空洞的影响占主导地位。
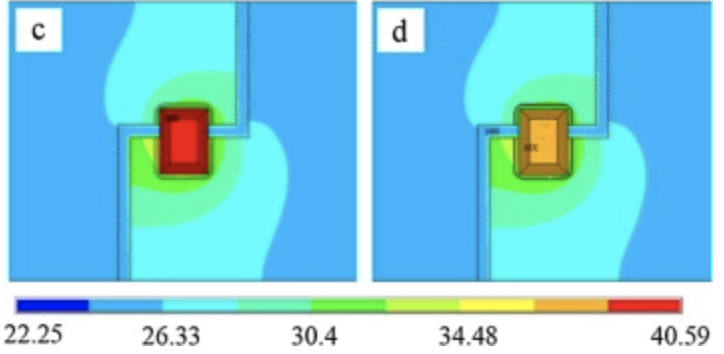
图3.倒装LED表面温度。c: 焊料厚度20μm, d: 焊料厚度30μm。
3. 福英达锡膏
深圳市福英达能够为客户提供优质的T6级以上的SAC305锡膏。福英达的SAC305锡膏粘度稳定,润湿性好,键合强度高。欢迎有锡膏焊料需求的客户与我们联系。
4. 参考文献
Liu, Y., Leung, S.Y.Y., Zhao, J., Wong, C.K.Y., Yuan, C.A., Zhang, G.Q., Sun, F.L. & Luo L.L. (2014). Thermal and mechanical effects of voids within flip chip soldering in LED packages. Microelectronics Reliability, pp.2028-2033.









 返回列表
返回列表



