机械应力和热应力下的BGA焊点可靠性-深圳市福英达

机械应力和热应力下的BGA焊点可靠性
BGA(球栅阵列封装)是一种常见的集成电路封装技术,它具有接触面积大、信号传输效率高等优点。然而,BGA焊点位于器件底部,不易检测和维修,而且由于BGA功能高度集成,焊点容易受到机械应力和热应力的影响,导致开裂或脱落,从而影响电路的正常工作。本文将分析应力作用下BGA焊点开裂的原因,并提出相应的控制方法。
机械应力和热应力是BGA焊点开裂的主要因素
机械应力是指物体受到外力而变形时,在其内部各部分之间产生的相互作用力。BGA焊点在装配和使用过程中,可能会受到来自不同方向的机械应力,如振动、冲击、弯曲等。这些应力会导致焊点内部产生裂纹,甚至断裂。
热应力是指物体由于温度变化而产生的胀缩变形,在外界或内部约束的作用下,不能完全自由变形而产生的内部应力。在高温作用下,焊点内部将持续产生热应力,导致疲劳累积,造成焊点断裂。

图1. BGA焊点开裂
IMC过厚会降低焊点可靠性
IMC是焊料与焊盘之间形成的一种金属化合物,它对焊点的强度和可靠性有重要影响。在无铅工艺条件下,由于焊接温度比有铅工艺更高,时间更长,因而IMC的厚度相对更厚。再加上无铅焊料本身比较硬,使得无铅焊点比较容易因应力而断裂。
如果BGA原始的IMC特别厚,即超过10μm,那么,在再流焊接时,IMC很可能发展成宽的和不连续的块状IMC,如图所示。这种IMC相对于正常IMC,其抗拉和抗剪强度会低 20%左右,在生产周转和装配过程中,容易因操作应力而断裂。
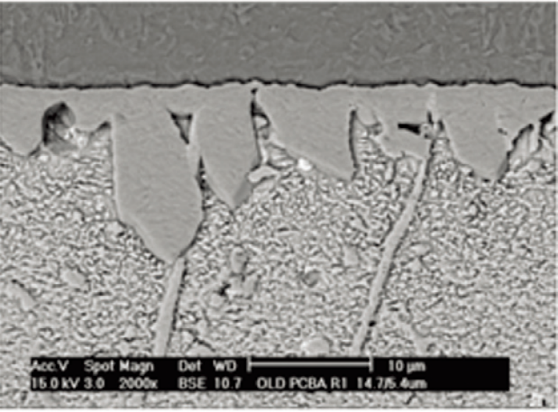
图2. 块状IMC
BGA焊点开裂的控制方法
1.严格管控焊接温度和时间,避免IMC持续生长。
2.采用低Ag+Ni无铅焊料。Ag+Ni无铅焊料具有优良的抗机械振动性能。 Ag是加速界面IMC生长的元素,Ni对Cu3 Sn的生产具有抑制作用,低Ag+Ni可以有效阻止IMC生长。
3.减轻部件重量、增加机构件如散热器的托架、增加产品工作时刚性避免剧烈振动等,或变更生产工艺如使用胶黏剂加固等,以此提升焊点抵抗机械应力的能力。









 返回列表
返回列表



