热梯度在锡膏焊接中的应用-深圳市福英达

热梯度在锡膏焊接中的应用-深圳市福英达
当前微电子行业的封装朝着高密度和小体积方向发展,此举显然是为了拓展摩尔定律。因此在封装中用到的锡膏/焊点往往直径细小。微小焊点内的晶粒的类型和性质对于研究焊点的性质变得至关重要。热梯度键合是一种目前讨论较多的焊接方法,不少人认为热梯度的应用能够通过固液互扩散键合控制金属间化合物(IMCs)定向生长,从而获得特定性能的微小焊点。与之相反的是,固液互扩散键合在等温条件下需要很长时间来形成完整的IMCs,并且IMCs的取向很难精确控制。
1. 热梯度键合实验
为了深入了解热梯度对焊接的影响。Zhang等人采用了SAC305来键合上下端的铜焊盘。两个铜焊盘的尺寸都为10×10×2mm。热梯度键合采用加热台来实现,加热台的热端温度为400℃,冷端温度为100℃。
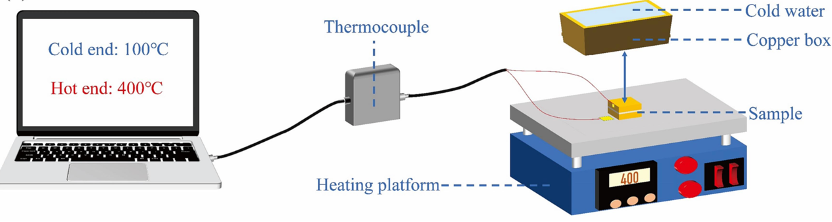
图1. 热梯度键合实验。
2. 热梯度键合实验结果
在加热过程中,可以明显观察到Cu6Sn5的形成。在Cu6Sn5和Cu焊盘之间的较薄IMC层是Cu3Sn。从图中可以发现,热梯度键合使IMCs生长速度发生变化。在热端IMCs没有表现出明显的生长,而冷端的IMCs生长速度很快。随着键合时间的增加,冷端IMCs数量显著增加,而热端IMCs变化不明显。此外,随着焊料层厚度增加,Cu6Sn5在热梯度键合焊点中呈现出细长的柱状形态。不同的是,等温焊接下的IMCs在焊点两端基本是对称生长。

图2. 热梯度键合的IMC生长。焊料层厚度: (a)20μm; (b)60μm; (c)100μm。
当焊料层厚度为20μm时,热梯度键合冷端IMCs的生长速度最快。随着厚度增加,冷端IMCs生长速度受键合时间的影响会逐渐减弱。因此热梯度键合可以通过控制焊料层厚度和键合时间来制造全IMC焊点。
下图显示了Cu/SAC305/Cu焊点中Sn晶界的错位取向分布。等温键合和热梯度键合的错位取向分布大致在0°-15°和55°-65°之间。然而,等温键合会使Sn晶界的错位取向分布更为分散,而热梯度键合能让对单个焊点中的Sn分布更集中。

图3. Sn晶界的错位取向分布。焊料层厚度:(a)20μm(热梯度); (b)60μm(热梯度); (c)100μm(热梯度); (d)100μm(等温)。
3. 福英达锡膏
深圳市福英达在焊料界深耕多年,有着丰富的SAC305,SnBi57.6Ag0.4等锡膏焊料的开发经验,产品焊接强度优秀,粘度可定制化,可适用于印刷和点胶等多种工艺。欢迎客户与我们了解更多产品信息。
4. 参考文献
Zhang, Z.Z., Hu, X.W., Chen, W.J., Tan, S.F., Chen, B., Wang, J., Jiang, J., Huang, Y.F., Zhu, G.Y., He, Y.S., Jiang, X.X. & Li, Q.L. (2023). Study of microstructure, growth orientations and shear performance of Cu/Sn-3.0Ag-0.5Cu/Cu solder joints by using thermal gradient bonding. Materials Characterization, vol.203.









 返回列表
返回列表



