μBGA、CSP在回流焊接中冷焊率较高的原因-深圳市福英达

μBGA、CSP在回流焊接中冷焊率较高的原因
在回流焊接过程中,对于密脚(间距≤0.5mm)的μBGA、CSP封装芯片来说,由于焊接部位的隐蔽性,热量向焊球焊点部位传递困难,存在冷焊发生率较高的风险。在相同的峰值温度和回流时间条件下,与其他热空气中焊点暴露性好的元器件相比,μBGA、CSP焊球焊点获得的热量明显不足。这就使得一些μBGA、CSP底部焊球的温度难以达到润湿温度,从而引发了冷焊问题。
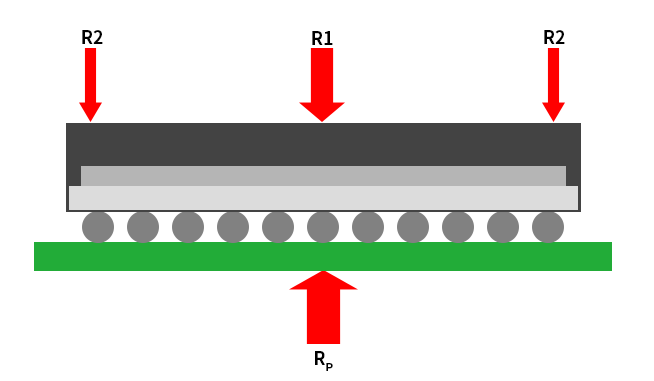
图1.CSP(芯片级封装)回流焊接的传热途径
冷焊是指在焊接中焊料与基体金属之间没有达到最低要求的润湿温度,或者局部发生了润湿,但冶金反应不完全而导致的现象。冷焊会导致焊点的质量下降,进而影响到元器件的可靠性和性能。
那么,如何降低μBGA、CSP在热风回流焊接中的冷焊率呢?根据冷焊产生的原因,可以从以下几个方面进行改进:
回流曲线是指在回流过程中温度随时间变化的曲线,它反映了元器件和PCB受热情况。为了使μBGA、CSP底部焊球能够充分加热和润湿,需要增加回流曲线中的峰值温度和保温时间。峰值温度应高于焊料球的液相线温度至少20℃,保温时间应保证焊料球能够完全融化并与焊盘形成良好的界面。同时,也要注意避免过高的峰值温度和过长的保温时间造成元器件或PCB过热损坏。
改进回流焊接热量的供给方式,如采用“红外+强制对流”加热。使用红外线作为主要的加热源达到最佳的热传导,并且抓住对流的均衡特性以减小元器件与PCB之间的温度差距。
封装体结构对于μBGA、CSP底部焊球加热有重要影响。一般来说,封装体越薄越小,其对焊球加热的阻碍越小。因此,可以通过减小封装体厚度和面积来提高焊球加热效率。另外,也可以在封装体内部增加金属层或其他导热材料来增强封装体内部的导热性能。
焊料球是μBGA、CSP与PCB连接的关键部分,其材料和直径对于冷焊问题有直接影响。一般来说,焊料球的材料应与PCB上的焊盘材料相匹配,以保证良好的润湿性能。焊料球的直径应根据封装体的密脚程度和PCB上的焊盘尺寸合理选择,以避免过大或过小造成的焊点缺陷。此外,焊料球的表面应保持清洁和光滑,以减少氧化和污染的影响。









 返回列表
返回列表



