主流无铅焊接实践
主流无铅焊接实践
福英达——研发中心——俞建文
摘要
铅不仅对水污染,而且对土壤、空气均可产生污染。电子制造业中大量使用的锡铅合金焊料( Sn/Pb)是污染人类生存环境的重要根源之一。因此,无铅焊接技术的应用是必然趋势。实现电子制造的全面无铅化,以减少环境污染,以适应国内外市场对绿色电子产品的需求,是电子制造业势在必行的举措。本文将从无铅合金和PCB板表面处理两方面介绍。
一.主流无铅合金
目前世界上无铅焊料主要有:SnCu(掺杂Ni,Co,Ce)、SnAg (+Cu,+Bi,+Sb,+掺杂,例如Mn,Ti,Al,Ni,Zn,Co,Pt,P,Ce)、SnZn (+Bi)。目前最流行的无铅合金是SnAgCu,其中Ag为1%-5%;而SnBi (+Ag) (熔点为140℃) 也越来越普遍。
在Sn-0.7Cu中加入Ni可以减轻铜腐蚀和不锈钢腐蚀,304型不锈钢腐蚀速率SAC305 > Sn-0.7Cu > Sn-0.7Cu-0.05Ni;铜腐蚀速率SAC305 > Sn63 > Sn-0.7Cu-0.05Ni[1]。在SAC中加入(Mn,Ti,Ce,Bi),在跌落测试中,耐冲击性SAC105+0.05Mn/Ce≈SnPb >105 >305;在热循环后耐冲击性SAC105+Ce > SAC105+Mn > 305 >105 >SnPb[2]。
如下图,随着热循环次数的增加,无铅合金裂纹比SnPb36Ag2更长,SnAg3.5,SnAg3.8Cu0.7 和SnAg2.6Cu0.8Sb0.5没有明显的差别,SnZn9的裂纹最长[3]。
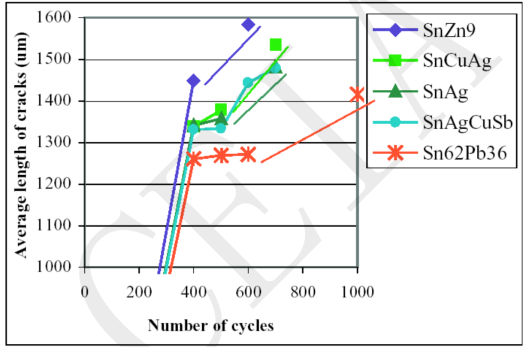
89Sn-8Zn3Bi焊点强度损失分析,是由于IMC层的生长和空洞的形成[4],如下图。
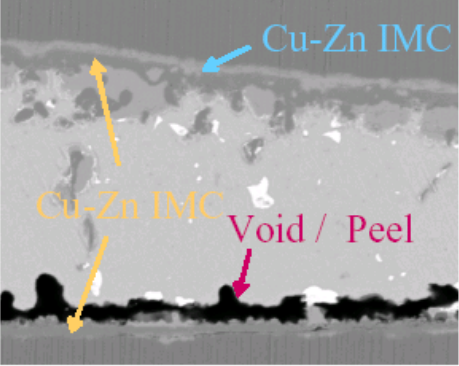
二.主流无铅PCB表面处理
主要分为OSP、镀Ni/Au(ENIG)、镀Ag、镀Bi、镀Pd、镀Ni/Pd、镀Ni/Pd/Au (ENEPIG)、镀Ni/Pd(X)、镀Sn(SnAg、SnBi、SnCu、SnNi)。
1.OSP
OSP就是在洁净的裸铜表面上,以化学的方法长出一层有机薄膜。因为是有机物不是金属,所以比喷锡工艺还要便宜。
这层有机物薄膜的唯一作用是,在焊接之前保证内层铜箔不会被氧化。焊接的时候一加热,这层膜就挥发掉了。焊锡就能够把铜线和元器件焊接在一起。但是这层有机膜很不耐腐蚀,一块OSP的电路板,暴露在空气中十来天,就不能焊接元器件了。
1.1 OSP的优缺点
优点:具有裸铜板焊接的所有优点,过期的板子也可以重新做一次表面处理。
缺点:OSP透明无色,所以检查起来比较困难,很难辨别是否经过OSP处理。OSP本身是绝缘的,不导电,会影响电气测试。所以测试点必须开钢网加印锡膏以去除原来的OSP层才能接触针点作电性测试。OSP更无法用来作为处理电气接触表面,比如按键的键盘表面。OSP容易受到酸及温度影响。使用于二次回流焊时,需在一定时间内完成,通常第二次回流焊的效果会比较差。存放时间如果超过三个月就必须重新表面处理。打开包装后需在24小时内用完。
1.2 OSP的机理
OSP工艺,在铜表面加苯并咪唑的涂层,可以降低板子表面的氧化,如下图[5]。

下图分别为主流的OSP工艺表面涂层有机物分子和新型OSP工艺表面涂层有机物分子的TG-DTA曲线,新型的化合物分解温度比原始的高100℃[6]。


2.镀Ni/沉Au(ENIG)
ENIG是通过化学方法在铜面上包裹一层厚厚的,电性能良好的镍金合金并可以长期保护PCB。内层镍的沉积厚度一般为3-6μm,外层的金的沉积厚度一般为0.05-0.1μm。不像OSP那样仅作为防锈阻隔层,其能够在PCB长期使用过程中有用并实现良好的电性能。另外它也具有其它表面处理工艺所不具备的对环境的忍耐性。
2.1化学反应机理
(1)镀Ni过程
3NaH2PO2+3H2O+NiSO4→3NaH2PO3+H2SO4+H2+Ni0或
Ni+++H2PO2-+H2O→Ni0+H2PO3-+2H+
2R2NH·BH3+3Ni+++2H2O→NiB+2Ni+2R2NH+HBO2+6H++3/2H2
(2)P和Ni一样也会发生共沉积,化学反应如下
2H2PO2-+Hads→H2PO3-+H2O+OH-+P
3H2PO2-→H2PO3-+H2O+2OH-+2P
(3)沉Au过程
Ni0+2Au+→Ni+++2AuO
Ni+2Au(CN)2-→Ni+++2Au+4CN-
2.2 ENIG的优缺点
优点:ENIG处理过的PCB表面非常平整,共面性很好,适合用于按键接触面。ENIG可焊性极佳,金会迅速融入融化的焊锡里面,焊锡与Ni形成Ni/Sn金属化合物。
缺点:工艺流程复杂,而且想要达到很好的效果需要严格控制工艺参数。最麻烦的是,EING处理过的PCB表面在ENIG或焊接过程中很容易产生黑盘效益。黑盘的直接表现为Ni过度氧化,金过多,会使焊点脆化,影响可靠性。
3.化学镀镍钯浸金工艺(ENEPIG)
ENEPIG在镍和金之间多了一层钯,在置换金的沉积反应中,化学镀钯层会保护镍层防止它被交置换金过度腐蚀,钯在防止出现置换反应导致的腐蚀现象的同时,为浸金作好充分准备。镍的沉积厚度一般为3-6μm,钯的厚度为0.1-0.5μm。金的沉积厚度一般为0.02-0.1μm。
3.1电镀钯的化学机理
Pd2++NaH2PO2+H2O→PdO+NaH2PO3+2H+
3NaH2PO2→2P+NaH2PO3+2NaOH+H2
3.2 ENEPIG的优缺点
优点:防止“黑镍问题”的发生-没有置换金攻击镍的表面做成晶粒边界腐蚀现象。化学镀钯会作为阻挡层,不会有铜迁移至金层的问题出现而引起焊锡性焊锡差。化学镀钯层会完全溶解在焊料之中,在合金界面上不会有高磷层的出现。同时当化学镀钯溶解后会露出一层新的化学镀镍层用来生成良好的镍锡合金。能抵挡多次无铅再流焊循环。有优良的打金线(邦定)结合性。非常适合SSOP、TSOP、QFP、TQFP、PBGA等封装元件。
缺点:没有广泛应用,钯的价格昂贵,是一种短缺资源。同时与化镍金一样,其工艺控制要求严格。
福英达专注于微电子与半导体封装焊料领域20余年,福英达工业科技有限公司是一家全球领先的微电子与半导体封装材料方案提供商,国家高新技术企业,深耕于微电子与半导体封装材料行业,从合金焊粉到应用产品线完整,是目前全球唯一可制造T2-T10全尺寸超微合金焊粉的电子级封装材料制造商。福英达公司锡膏、锡胶及合金焊粉等产品广泛应用于微电子与半导体封装的各个领域。得到全球SMT电子化学品制造商、微光电制造商和半导体封装测试商的普遍认可。但微电子与半导体封装材料问题广泛,在此我们仅就常见问题展开了叙述。因工艺过程不同,其过程中所涉及到的问题也可能不尽相同。欢迎您就具体问题与我们的专业人员进行沟通讨论。我们希望同合作伙伴共同与时俱进,共同探究新问题、新技术以及复杂工艺,努力为合作伙伴提供专业、周到的微电子与半导体封装焊接材料服务。
参考文献
[1]. Keith Sweatman, Shoichi Suenaga, Masaaki Yoshimura and Tetsuro Nishimura (Nihon Superior), Masahiko Ikeda (Kansai University), “Erosion 5 of Copper and Stainless Steels by Lead-Free-Solders”, Apex, S27-4, Anaheim, CA, Feb, 2004.
[2]. Liu etc, SMTAI, p.920-934, October 4-8, 2009, San Diego, CA.
[3]. Günter Grossmann, Giovanni Nicoletti, Ursin Solèr , “Results of Comparative Reliability Tests on Lead-free Solder Alloys”, 52nd ECTC, S30-P1, San Diego, CA, May 28-31, 2002.
[4]. Hirokazu Tanaka, Yuuichi Aoki, Makoto Kitagawa and Yoshiki Saito (ESPEC CORP.), “Reliability Testing and Failure Analysis of Lead-Free 8 Solder Joints under Thermo-Mechanical Stress”, Apex, S28-1, Anaheim, CA, Feb, 2004.
[5]. Joseph D. DeBiase, “Organic Solderability Preservatives: Benzotriazoles and Substituted Benzimidazoles”, SMI 96, San Jose, CA, September 10-12, 1996.
[6]. Koji Saeki, (Shikoku Chemicals Corporation) and Michael Carano,
(Electrochemicals, Inc.), “Next Generation Organic Solderability Preservatives (OSP) for Lead-free soldering and Mixed Metal Finish PWB’s and BGA Substrates”, Apex, S10-2, Anaheim, CA, Feb, 2004.









 返回列表
返回列表



