5G应用和封装工艺
5G应用和封装工艺
随着通讯技术发展,用户对网络性能和续航提出了更高的要求。对此近些年多家手机厂商相继开发出了手机5G芯片,芯片的高度集成大大加快的网络速度和稳定性。5G芯片的集成度极高且体积越来越小。目前芯片大小已经可达5nm,并且3nm芯片也正在研发中。 不仅是手机,5G在通讯行业,AI,物联网等领域同样有着巨大潜能。
5G技术引进了毫米波概念 (mmWave)。相比于Sub-6频段,毫米波可以提供更大的带宽,等于通信速度加强数倍。众所周知波长和频率成反比,由于5G毫米波需要高频率实现,因此天线发出的波长需要很短,这减小了天线的长度。但更短的波长容易使信号受到干扰并衰减,并需要更多的天线来实现信号覆盖。5G手机和车用雷达集成了各种各样的射频组件和天线,数量远超4G。基板尺寸只有30x30mm,并且基板线宽和线距小于20μm。结合以上原因,毫米波天线模组目前采用AiP (Antenna in Package )封装工艺。该封装能将前端组件,开关,滤波器等通过SiP技术集成在一起,达到缩小尺寸,减少传输距离,降低系统损耗的目的。TMYTEK考虑了三种AiP制造技术,包括低温共烧陶瓷(LTCC) 和高频PCB。 基于PCB,目前TMYTEK公司已经发展出了具有多层PCB的AiP模组,并实现1x8到8x8阵列产品。同时,TMYTEK使用具有优秀电气和封装特性的LTCC进行AiP设计并取得重大成果。

图1: AiP设计到制造流程
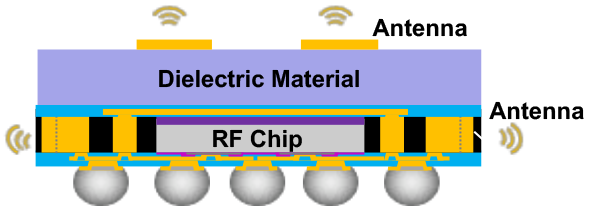
图2: AiP封装效果图
扇出型晶圆级封装 (FOWLP)为实现5G封装开辟了新思路。扇出型晶圆级封装将加工切割完的芯片放在环氧树脂模中,并利用RDL布线实现无基板封装。RDL可向内和向外布线,从而实现更多的I/O端口,更好的散热和更小的尺寸。台积电的集成扇出型封装技术(InFO)已经得到实践和应用。
深圳市福英达工业技术有限公司可提供用于5G芯片封装的焊料,欢迎了解和咨询。









 返回列表
返回列表



