无铅焊料金属间化合物形成机理和影响

https://www.szfitech.com/
无铅焊料金属间化合物形成机理和影响
1. 焊接界面金属间化合物介绍
目前主流和无铅焊料有锡银铜和锡铋类型。在使用无铅焊料与铜/镍焊盘进行焊接时,由于扩散机制的作用,在焊料和焊盘的界面处出现原子的扩散,并形成金属间化合物(IMC)。例如SAC305焊料和焊盘界面会形成IMC如(Cu,Ni)6Sn5等。IMC的生成可以分为四个阶段,包括溶解,扩散,凝固和反应过程。在回流过程中焊料的原子扩散到基板表面并通过界面反应形成IMC。在降温后IMC在焊料中积累。扩散过程可以用Fick第一定律表示。

m: 扩散量
D: 扩散系数
S: 接触面积
dc/dx: 扩散元素浓度梯度
dt: 扩散时间
2. SAC305微凸点IMC生长机制
当SAC305焊料与镍焊盘形成微凸点后,在焊盘与焊料中间出现了IMC层。由横截面背散射图(BSE)可见 (图1),镍焊盘一侧的黑色薄层的IMC为Ni3P,针状IMC为(Ni,Cu)3Sn4,体型稍小的白色状颗粒IMC为Ag3Sn。界面处最开始时生成IMC为(Cu,Ni)6Sn5,但是随着Cu含量消耗(Cu,Ni)6Sn5开始溶解。Cu原子析出进入到Ni3Sn4并取代了Ni的位置形成(Ni,Cu)3Sn4。
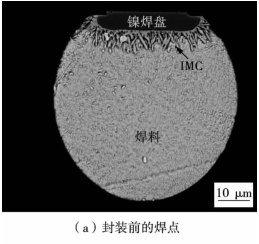
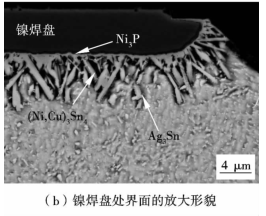
焊料中的Cu含量是影响Ni/SnAgCu界面IMC的主要因素 (Tian et al., 2013)。当Cu的含量在0.4-0.6%,界面形成(Cu,Ni)6Sn5 和(Ni,Cu)3Sn4。而小于该范围则生成(Ni,Cu)3Sn4 。大于该范围则是(Cu,Ni)6Sn5。此外实验发现Ni原子能够降低Cu原子在锡焊料中的溶解度并影响(Cu,Ni)6Sn5的生长(Tian et.al., 2013)。
原子间的扩散是持续进行的。研究发现在IMC层随温度和时间增加而变厚。由下表可知,更高的峰值温度和更长加热时间使IMC的厚度增大。
表1: IMC厚度和温度时间的关系。
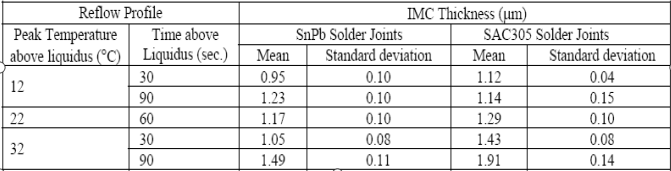
3. 金属间化合物的影响
较薄且均匀分布的IMC可以对焊点起到增强作用。但是IMC本身是脆性,在热老化作用下会出现大片块状的IMC,导致焊点内部应力增加并加大焊点脆性,在受到外力作用下会使焊点出现裂纹并导致失效。SAC305 微凸点与铜焊盘完成焊接后,长时间的热老化会在Cu焊盘一侧催生Cu3Sn并削弱焊点强度。
4. 参考文献
Tian, Y., Wu, Y.P., An, B., & Long, D.F. (2013). The Formation and Growth of Intermetallic Compound at the Interface of Fine-Pitch Flip-Chip when Interconnecting”, Transactions of the China Welding Institution, 34(10).
https://www.szfitech.com/









 返回列表
返回列表



