电镀共晶SnBi锡膏凸点的性质

https://www.szfitech.com/
电镀共晶SnBi锡膏凸点的性质
电子封装行业的趋势要求更轻、更小、更灵活的产品。为了实现芯片的微型化,焊盘间距变得越来越小。此外为了充分利用芯片空间,越来越多厂家采用倒装封装工艺,这种工艺能够产生更多的I/O接口数量,更好的电气性能和更小的封装体积。研究者发现使用电镀锡膏制作凸点可以满足倒装封装的要求。电镀锡膏工艺能够解决成本问题,规模生产问题和满足细间距要求。共晶锡铋锡膏是适用于制作微凸点的焊料,熔点低且机械性能良好。
倒装芯片需要在凸点下制作金属层。然后在焊盘上沉积锡膏并回流成为焊点。采用商业电镀直流脉冲电镀装置能够将共晶Sn-Bi锡膏电镀到焊盘上。 Roh et al. (2014) 进行电镀共晶SnBi锡膏实验并测试焊点可靠性。恒定的电位和电流密度是稳定电镀的关键。以30 mA/cm2电镀15分钟可制成柱状 Sn-Bi 凸点,平均凸块直径和高度为分别为22 ± 0.4和18 ± 06 lm (Roh et al., 2014)。
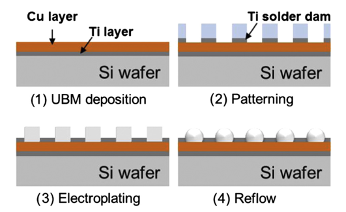
图1. 电镀SnBi锡膏凸点流程示意图 (Roh et al., 2014)。
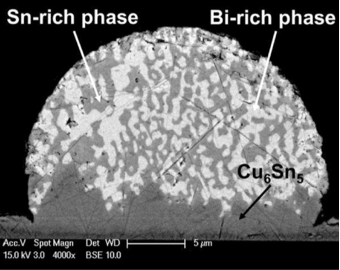
图2. 170℃回流20分钟后的焊点横截面图 (Roh et al., 2014)。
在170℃回流20分钟后, 锡膏润湿焊盘并形成半球形焊点。图2白色部分是富铋相而灰色的是富锡相。同时可以观察到焊点出现金属间化合物Cu6Sn5生长。Cu6Sn5的生长是和回流时间有关系的。回流时间越长则会导致更多的Cu6Sn5。其他IMCs例如Cu3Sn并不会在回流中生成。通常来说Cu3Sn在老化测试中会逐渐出现,并随着老化时间增加而增加。
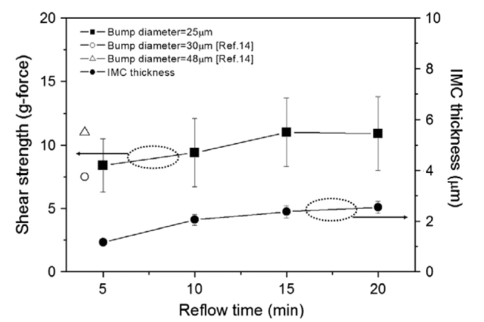
图3. 回流时间和剪切强度的关系 (Roh et al., 2014)。
由图3可以看到,随着回流时间增加,电镀共晶SnBi凸点剪切强度增加。但是不能过长的回流,否则由于IMC的过度生长,焊点会变得脆性并导致断裂。脆性断裂还发生在热老化中。随着老化时间增加,脆性IMC自发生长并最终导致脆性断裂。目前很多实验结论表面,掺杂纳米金属颗粒能够改善脆性断裂问题。共晶SnBi凸点的硬度较低,可根据实际需要应用在特定元器件上。
深圳市福英达是致力于生产高可靠性锡膏的厂家,产品涵盖各种合金组合,例如锡铋和锡银铜等,欢迎进一步了解。
参考文献
Roh, M.H., Jung, J.P., & Kim, W.J. (2014), “Microstructure, shear strength, and nanoindentation property of electroplated Sn–Bi micro-bumps”, Microelectronics Reliability, 54, pp. 265-271.









 返回列表
返回列表



