无铅锡膏的应用_电路板镀镍层对焊接的影响

无铅锡膏的应用: 电路板镀镍层对焊接的影响
微电子领域的发展趋势需要高性能和高密度电子元件。然而金属间化合物(IMC)会对高密度电子元件的可靠性造成影响。电路板的表面处理对IMC的形成有一定影响。目前市场已经研究了几种电路板表面处理方法以改善焊接效果,包括有机保焊剂(OSP),化镍浸金(ENIG),化学镍钯金(ENEPIG)等。其中ENIG和ENEPIG表面处理的电路板受到广泛应用。对于ENIG和ENEPIG,不同镍层厚度会对焊接效果产生影响。本文简单介绍镍层对焊接的影响。
电路板镍层对可焊性影响
业界普遍发现ENIG工艺存在出现黑盘的风险。黑盘效应的形成原因是因为镍原子球形小于金原子,由于原子大小不一致,镀金后晶粒粗糙。并且镀金液会渗透到镍层并将其腐蚀,形成的黑色氧化镍可焊性差。因此称作黑盘效应。由于镀镍层的氧化,使用锡膏焊接时难以形成冶金连接,形成的焊点易脱落。
为了解决黑盘问题,业界又推出了ENEPIG表面处理技术。该技术在镍层上镀上了钯,有效地避免了镍层被腐蚀。除了黑盘问题,镍层对IMC生长也有影响。ENEPIG的镍层厚度还需要进一步优化。为了研究ENEPIG镍层厚度的影响,Kim等使用SAC305锡膏在ENEPIG处理的电路板上完成焊接。他们采用了不同厚度的超薄镍层ENEPIG处理的电路板进行分析。
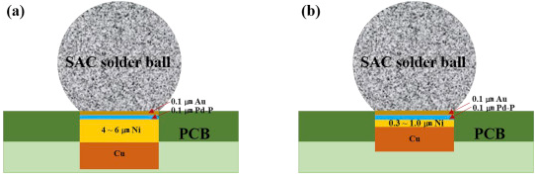
图1. SAC305锡膏在ENEPIG电路板上焊接示意图。(a)镍层4-6μm;(b)镍层0.3-1μm。
镍层厚度对IMC的影响
由图2可以看到,所有的镍层厚度都会有(Cu,Ni)6Sn5形成。在焊接时,镍层上的Au和Pd会熔化到SAC305锡膏中,随后焊料中的Sn和Cu会扩散到镍层并发生反应生成(Cu,Ni)6Sn5。此外,当镍层较薄时,(Cu,Ni)6Sn5的生长速度更快。

图2. SAC305锡膏在ENEPIG电路板上焊接效果。(a)镍层0.3μm;(b)镍层0.5μm; (c)镍层0.7μm; (d)镍层1μm。
当老化1000小时后,镍层厚度为0.3μm的样品(Cu,Ni)6Sn5层厚度最大,远远大于厚度为1μm的情况。此外,如果镍层厚度小,(Cu,Ni)6Sn5还会在大量扩展到界面底部。当镍层厚度增加到0.7μm以上,界面底部的(Cu,Ni)6Sn5变得很少。这是因为富P镍层在老化过程中充当Sn和Cu扩散的屏障,减缓了IMC生长。此外,镍层厚度越小,生成的IMC总厚度会越大。
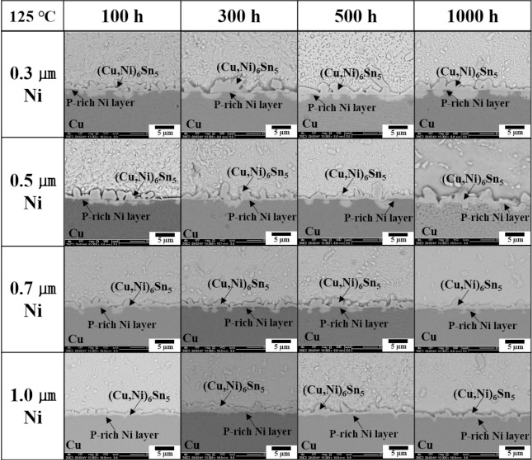
图3. SAC305锡膏焊点在125℃老化1000小时。
镍层对焊接机械强度的影响
当镍层的厚度为0.3μm时,老化后的焊接强度最差,且焊点失效概率远大于镍层厚度为0.7μm和1μm的样品。镍层较薄会带来更多的IMC,IMC的富集会导致焊点脆性增加,老化后容易出现脆性断裂。同时脆性断裂还和老化温度有关,对于镍层厚度较小的焊点,IMC生长对高温更敏感,脆性断裂增速更快。
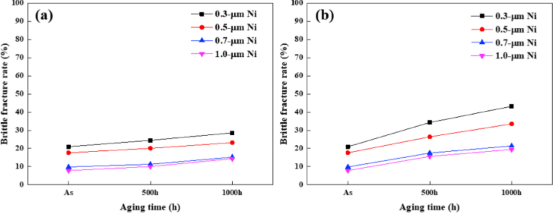
图4. 镍层厚度和机械强度关系。(a)125℃老化;(b)150℃老化。
深圳市福英达能够生产适用于ENIG和ENEPIG表面处理电路板的锡膏产品。福英达的锡膏产品润湿性好,焊后机械强度,导热和导电性能优秀。欢迎与我们联系。
参考文献
Kim, J., Jung, S.B. & Yoon, J.W. (2019). “Optimal Ni(P) thickness and reliability evaluation of thin-Au/Pd(P)/Ni(P) surface-finish with Sn-3.0Ag-0.5Cu solder joints”. Journal of Alloys and Compounds, vol.805, pp.1013-1024.









 返回列表
返回列表



