锡膏介绍_ 焊料层厚度对Cu3Sn相的影响

锡膏介绍: 焊料层厚度对Cu3Sn相的影响
微电子封装技术随着工艺的演进和使用需求的提高,衍生出了3D封装和晶圆级封装等先进集成技术。Cu-Cu互连和Cu-Sn-Cu互连是封装中最为常见的形式。无铅锡膏作为焊接材料,能够与铜发生冶金反应,从而起到连接铜凸点和铜焊盘的作用。但是金属间化合物(IMC)生长在无铅锡膏焊接体系中难以避免。IMC生长会对小型化封装的机械性能和热电性能造成影响。为了优化焊后IMC厚度,有大量研究者分析了焊料层厚度对劣性Cu3Sn相的影响。
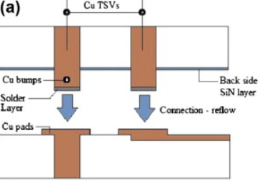
图1. Cu-Sn-Cu互连结构图。
在焊接过程中,熔融状态的无铅锡膏会与Cu反应,使得Cu6Sn5在Cu–Sn界面成核。Cu原子持续溶解,直到界面处锡膏变得过饱和,Cu6Sn5微晶可以成核并快速生长。Sn和Cu的扩散是造成Cu6Sn5形成的主要原因。Cu3Sn的出现更多是在老化过程中发生的。
Cu3Sn相的生长机制
相比于刚完成回流焊接,热老化会大大增加IMC的总厚度。在老化过程中,Sn会持续扩散为IMC生长提供驱动力。因此,在老化过程中,总厚度不断增加。但是Sn层最终会耗尽。在Sn耗尽后,Cu6Sn5会逐渐被消耗并形成Cu3Sn,致使Cu6Sn5厚度下降。

焊料层厚度对Cu3Sn的影响
在常规焊接工艺中,焊料层的厚度大概在20μm左右。当焊料层的厚度较大时,可流动的Sn量更多,Cu6Sn5的生长速度很快,而Cu3Sn相的出现受到了抑制。并且需要更长的老化时间较长来实现Sn的完全消耗,然后Cu3Sn才开始慢慢长大。Li和Chan尝试将无铅锡膏焊料层的厚度缩小为亚微米级别, 从而验证焊料层厚度对IMC生长的影响。

图2. 焊料层厚度为1μm时IMC层的生长情况。(a)刚回流完成; (b)老化100h; (c)EDX结果; (d)IMC变化趋势。

图3. 焊料层厚度为500nm时IMC层的生长情况。(a)刚回流完成; (b)老化100h; (c)老化500h; (d)IMC变化趋势。
由图2可以看到,焊料层明显出现分层现象,也就是出现Cu6Sn5和Cu3Sn层。在老化后Sn层继续为IMC层提供Sn原子,并促进IMC的生长。对比图3可以发现,当焊料层厚度为500nm时也能观察到Cu6Sn5和Cu3Sn层,但是数量较少,分界不明显。由于Sn量太少,在回流期间就基本被耗尽。Cu3Sn的成核和生长是通过消耗Cu6Sn5Sn来实现的。此外,显然可以发现焊料层薄会造成IMC数量更少,且Cu6Sn5厚度不足,转化为Cu3Sn的速度也变慢。
深圳市福英达能够生成用于微间距焊接的超微锡膏, 润湿性好,焊接可靠性高。欢迎进入官网了解更多信息。
参考文献
Li, Q. & Chan, T.C. (2013). “Growth kinetics of the Cu3Sn phase and void formation of sub-micrometre solder layers in Sn–Cu binary and Cu–Sn–Cu sandwich structures”. Journal of Alloys and Compounds, vol.567, pp.47-53.









 返回列表
返回列表



