中温焊料_BGA焊点的热断裂失效机制

中温焊料: BGA焊点的热断裂失效机制
BGA的出现是为了满足增加集成电路的I/O接口数量的需求,已经在高密度封装大量采用。与传统微电子封装技术相比,BGA是使用合金焊料球代替引脚来完成信号传输,降低了电信号的传输损耗。但是高密度的集成也带来了更高的服役温度,对BGA的热老化可靠性带来了挑战。在高温作用下,焊点内部会持续产生热应力,导致疲劳累积,最终可能导致焊点断裂。
众所周知IMC的出现是无铅锡膏焊接难以避免的。由于IMC在老化过程的生长是决定焊点可靠性的关键因素,因此需要了解热疲劳过程中的焊点微观结构变化,从而推断出IMC对BGA焊点可靠的影响。如图1所示,Li等人采用中温焊料SAC305 BGA完成与Sn63Pb36锡膏层和Sn62Pb36Ag2锡膏层的装配,并进行热循环测试(-55℃-125℃)。中温焊料SAC305 BGA的顶部与芯片的Ni焊盘连接,底部与PCB的Cu焊盘连接。
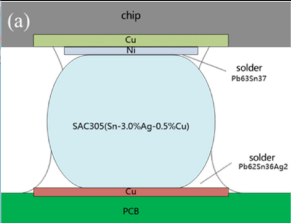
图1. BGA焊点示意图。
BGA焊点老化测试结果
如图2所示。无铅焊料SAC305 BGA中的灰色相为Sn,白色相为Pb。在刚完成焊接时焊点结构精细。在600次热循环后,Pb进一步扩散到了BGA中,并且Pb晶粒开始粗化。此外,在完成1200次热循环后,在BGA-芯片一侧和BGA-PCB一侧都可以清楚地看到由Pb晶粒进一步粗化并积聚形成网络结构。
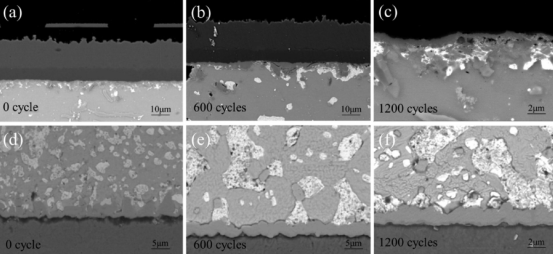
图2. BGA焊点老化测试。(a-c)BGA-芯片一侧; (d-f)BGA-PCB界面一侧。
在热循环3200次后,BGA-芯片一侧大致分为了Ni区,IMC(Cu,Ni)6Sn5区,Sn区。可以观察到Sn区出现了晶粒粗化和再结晶现象。(Cu,Ni)6Sn5区则是出现了一定程度的位错。另外,在BGA-PCB一侧可以看到AC区和BC区的界面出现了较长的裂纹,并沿着的晶界向外扩展(图4),形成穿晶裂纹。这为焊点连接处断裂的出现带来隐患。图4(c)还可以看到有空洞的形成。在空洞和裂纹的共同作用下,该区域受到应力时将更容易出现断裂。此外,BGA-PCB一侧的D区会有晶粒错位。

图3. 热循环3200次后的BGA-芯片界面一侧的微观结构。(b): 图(a)的成分分布; (c): 图(a)虚线区放大图; (d): 图(a)实线区放大图。

图4. 热循环3200次后的BGA-PCB一侧的微观结构。(b): 图(a)的成分分布; (c): A区放大图; (d): C区放大图。
焊点断裂分析
无铅焊料BGA焊点,焊料层和焊盘等材料的热膨胀系数不匹配是焊点热老化失效的主要诱因。当元件使用过程产生热应力,材料的膨胀使得焊点内部和表面出现应力并逐渐累积。Li等表示Sn晶粒再结晶和(Cu,Ni)6Sn5的位错能释放部分应力。(Cu,Ni)6Sn5倾向扩散到芯片焊盘的Ni层并形成网格结构,也可以释放应力。可以知道的是Ni层起到抑制原子扩散的作用,减缓IMC生长,从而减缓断裂失效速度。而BGA-PCB界面处没有Ni层的阻隔,Cu6Sn5生长速度更快,在应力作用下会出现穿晶裂纹。
深圳市福英达可生产中温超微锡膏产品,能够替代BGA焊料球用于高密度微间距封装。同时中温超微锡膏产品也可用于制作BGA焊盘上的焊料层。欢迎与我们联系。
参考文献
Li, Q.H., Zhao, W., Zhang, W., Chen, W.W. & Liu, Z.Q. (2022). “Research on Thermal Fatigue Failure Mechanism of BGA Solder Joints Based on Microstructure Evolution”. International Journal of Fatigue.









 返回列表
返回列表



