通过添加纳米强化钨(W)改善Au/Ni/Cu焊盘上Sn57.6Bi0.4Ag焊点的时效和电迁移力学性能-深圳市福英达

通过添加纳米强化钨(W)改善Au/Ni/Cu焊盘上Sn57.6Bi0.4Ag焊点的时效和电迁移力学性能
在Au/Ni/Cu焊盘焊料回流过程中(Au,Ni)(Sn,Bi)4 颗粒的形成
在形成焊点时,Au/Ni/Cu焊盘中的整个Au层迅速溶解到熔融焊料中,导致在回流焊点的焊料区域内形成大量的(Au,Ni)(Sn,Bi)4 金属间化合物(IMC)颗粒。回流接头的界面IMC区均为(Ni,Cu)3Sn4 薄层。
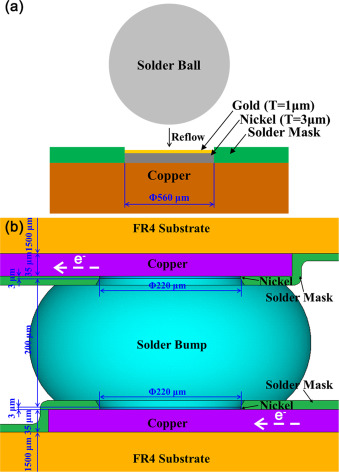
图1.原理图:(a)用于界面反应分析的衬底和(b)用于电迁移测试的焊料互连(符号T指厚度,标有符号e−的箭头表示电子流方向)。

图2. Au/Ni/Cu衬底上回流(a和b) Sn57.6Bi0.4Ag和(c和d) Sn57.6Bi0.4Ag- w焊点的界面微观结构和焊料凸点。
焊点在老化过程中发生脆性断裂
在时效过程中,由于界面层(Au,Ni)(Sn,Bi) 4imc的形成而发生脆性断裂。随着Au向界面迁移,Au在结合部聚集,形成厚层(Au,Ni)(Sn,Bi)4 IMC。这种积累导致断裂路径向界面IMC区域转移,转变为脆性断裂,并由于Au脆化导致接头强度恶化。(Au,Ni)(Sn,Bi)4在接头界面处的积累导致接头强度严重退化,可靠性问题严重。断裂路径向界面IMC区转移,并向脆性断裂特征转变。因此,在时效过程中,监测和控制金属间化合物的形成是很重要的,这些化合物会导致脆性断裂和接头强度的退化。
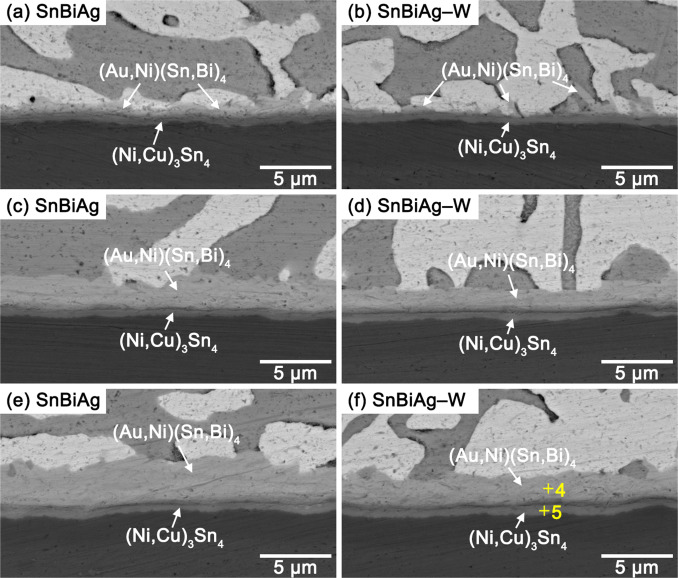
图3. Au/Ni/Cu衬底上(a、c、e) Sn57.6Bi0.4Ag和(b、d、f) Sn57.6Bi0.4Ag- w焊点在100℃等温时效(a、b) 240 h、(c、d) 480 h和(e、f) 720 h后的界面组织。
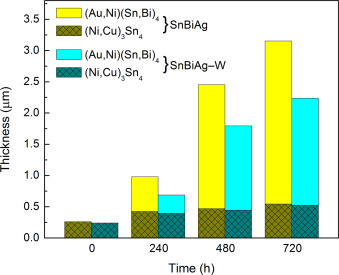
图4. 不同时效时间下钎料与Au/Ni/Cu衬底界面imc的平均厚度。
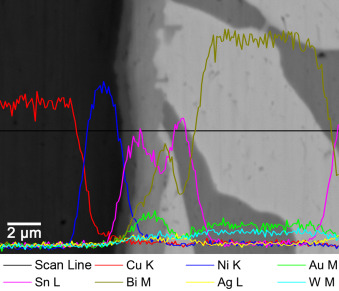
图5. EDX线扫描显微照片显示了在100°C时效720 h后SnBiAg-W/Au/Ni/Cu界面的元素分布。
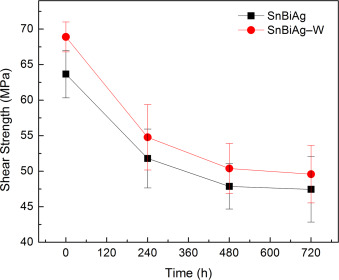
图6. Au/Ni/Cu焊盘上SnBiAg和SnBiAg- w焊点在不同时效时间后的球剪切强度

图7. Au/Ni/Cu焊盘上回流(a和b) SnBiAg焊点和(c和d) SnBiAg- w焊点的剪切断口放大视图。
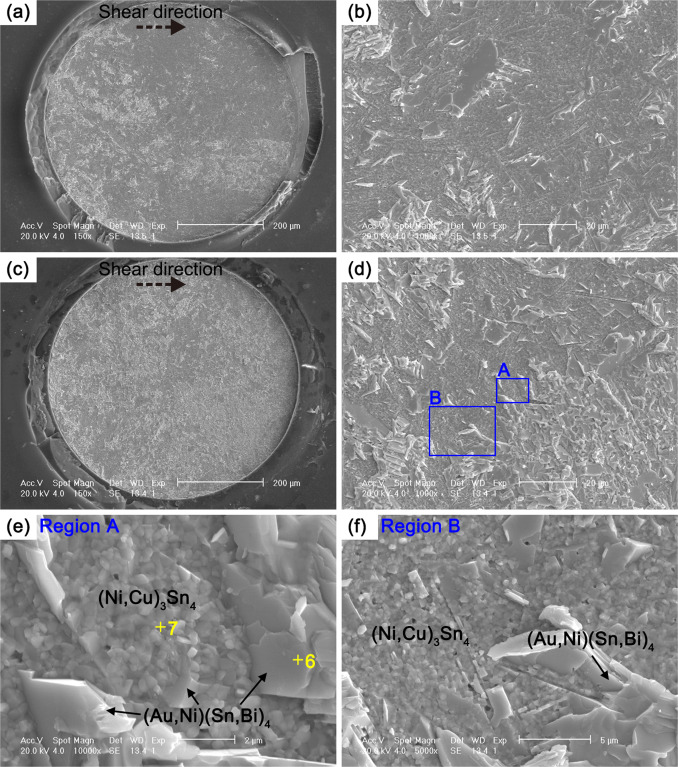
图8. Au/Ni/Cu焊盘上(a和b) SnBiAg和(c和d) SnBiAg- w焊点在100°c时效720 h后的剪切断口放大视图,(e)区域a和(f)区域b的高放大图像。
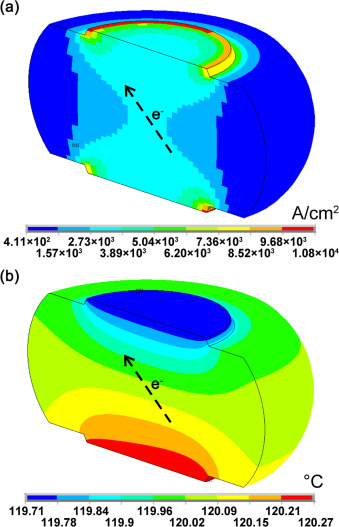
图9. (a)焊料凸点区域的电流密度和(b)温度分布。
W纳米颗粒的加入影响钎料合金的微观结构
W纳米颗粒的加入细化了钎料合金的微观结构,产生了细化强化机制。它降低了富sn和富bi交替层间的平均界面间距,对钎料基体有显著的细化作用。W纳米颗粒的加入也缩短了分散颗粒之间的平均距离,提高了力学性能。降低钎料基体层间相间距对钎料基体有显著的细化效果。这种细化效应是由于W纳米颗粒的加入导致凝固过程中形核位点数量的增加。

图10. (a) W纳米颗粒的SEM图像和(b) XRD谱。

图11. (a, b, c) SnBiAg和(d, e, f) SnBiAg- w焊料在0.5×104 a /cm2、100℃下电迁移720 h后,微观结构互连,阳极和阴极界面放大图像。
在回流焊过程中,Au/Ni/Cu焊盘中的整个Au层迅速溶解到熔融焊料中,在回流焊接头的焊料区域内形成大量的(Au,Ni)(Sn,Bi)4金属间化合物(IMC)颗粒。回流接头的界面IMC区均为(Ni,Cu)3Sn4薄层。W纳米颗粒的加入提高了回流接头的强度。
在Au/Ni/Cu焊盘上添加纳米钨(W)增强剂对Sn57.6Bi0.4Ag焊点具有改善作用。W纳米颗粒的加入成功地提高了钎料合金的力学性能,显微硬度得到提高。
参考文献
Yi Li, Kaiming Luo , Adeline B.Y. Lim, Zhong Chen, Fengshun Wu, Y.C. Chan(2016). Improving the mechanical performance of Sn57.6Bi0.4Ag solder joints on Au/Ni/Cu pads during aging and electromigration through the addition of tungsten (W) nanoparticle reinforcement. Materials Science & Engineering, A. Structural Materials: Properties, Misrostructure and Processing, vol. 291-303.









 返回列表
返回列表



