SAC305在电迁移和热冲击时的性能演变-深圳福英达

SAC305在电迁移和热冲击时的性能演变-深圳福英达
对于电子封装密度越来越高的设备来说,高电流密度和微小的焊料直径使得焊点可靠性面临电迁移等问题。为了解决这些问题,有必要了解锡膏焊料的微观结构演变和失效机制。并且当焊料在受到热冲击时,热量和电迁移的共同作用会加速原子扩散和热应力的形成,从而导致金属间化合物(IMC)的过度生长。另外热冲击会使得热膨胀系数不一致会加速焊接失效。
实验过程
为了深入了解焊料在热冲击和电迁移时焊点会发生哪些变化,Li等人对SAC305进行一系列的热冲击(-196℃到150℃)和电迁移测试(电流密度: 2*10^4A/cm^2),并分析了焊点微观结构演变和失效机制。图1(a)显示了尺寸为20mm*20mm的测试模块,由4个尺寸300μm的SAC305焊球组成,焊盘直径为250μm,且芯片焊盘上镀有镍层。通过两个回流工艺焊接锡球和芯片。
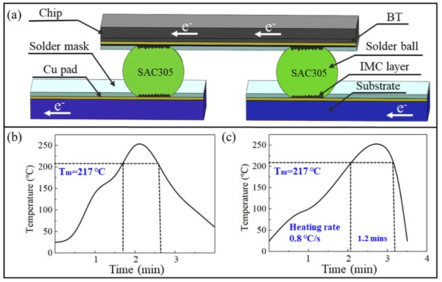
图1. 测试单元和回流曲线。
实验结果
IMC结构
在对SAC305焊点通电并进行热冲击循环后,左侧焊点在15次热循环后,在阳极界面处检测到连续的(Cu, Ni)6Sn5 IMC层,并且由于电迁移的电子流驱动Sn和Ni原子向阳极迁移,阳极IMCs的形态从扇贝状变为平面型。在阴极界面处也有非常薄的(Ni, Cu)3Sn4层。对于右侧焊点,在阳极和阴极界面分别形成了(Ni, Cu)3Sn4和Cu6Sn5。(Ni, Cu)3Sn4的厚度随着电迁移时间增加而变厚,这归因于焊点原子随着电子流从阴极迁移到阳极。

图2. 热冲击测试后的IMC变化。
失效模式
在左侧焊点的上界面处观察到痕量Cu的溶解。局部痕量溶解的发生可以用SAC305焊点的凝固和电迁移后热循环来解释。电流倾向于选择电阻最低的路径,这也促进了电子在电子流进入焊点的位置积聚,导致在入口处产生电流拥挤和焦耳热。因此,由于焦耳热累积,在拐角处观察到焊点的局部Cu溶解。此外,由于不同结构的CTE不匹配和晶格畸变,裂纹沿着阴极界面扩展导致焊点失效。类似的,右侧焊点在热循环后也出现了Cu焊盘的局部快速溶解,并在阳极界面处形成裂纹。
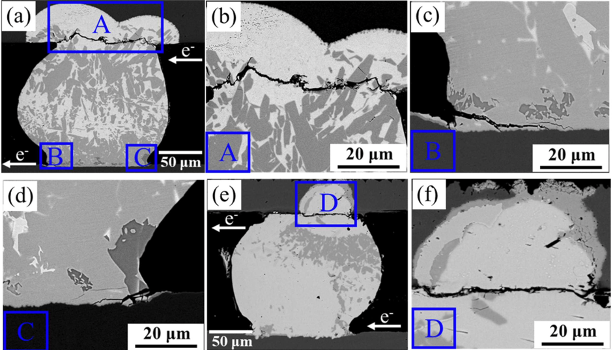
图3. 18次热冲击后焊点的失效机制。(a-d)左侧焊点; (e-f)右侧焊点
在6次热循环之前,阴极侧剪切表面上发现了细长的断裂凹坑。因此,该断裂形式属于韧性断裂。在6次循环后,在剪切表面上检测到Ni3Sn4 IMC(红色),这一现象表明焊点的断裂模式转变为韧性-脆性混合断裂。随着热循环次数继续增加,断裂口Ni3Sn4数量增加。阳极侧焊点也有着类似的断裂机制,即断裂机制从韧性断裂转变为韧性-脆性混合断裂。通过断裂模式可以知道阴极侧的剪切强度随着循环次数增加而下降。然而阳极侧强度先下降后上升,这是因为持续的极端的温度使得断裂面开始出现孪晶并增强了焊点的强度。


图4. 焊点阴极侧(上)和阳极侧(下)剪切失效图。(a)回流后; (b)3次循环; (c)6次循环; (d)9次循环; (e)12次循环; (f)15次循环。
参考文献
Li, S.L., Hang, C.J., Zhang, W., Guan, Q.L., Tang, X.J., Yu, D., Ding, Y. & Wang, X.L. (2023). Current-induced solder evolution and mechanical property of Sn-3.0Ag-0.5Cu solder joints under thermal shock condition. Journal of Alloys and Compounds.









 返回列表
返回列表



