利用环氧助焊剂提高倒装芯片封装的效率和可靠性-深圳福英达

利用环氧助焊剂提高倒装芯片封装的效率和可靠性
倒装芯片组装过程通常包括焊接、去除助焊剂残留物和底部填充。由于芯片不断向微型化方向发展,倒装芯片与基板之间的间隙不断减小,因此去除助焊剂残留物的难度不断增加。这不可避免地会导致清洗成本增加,或影响底部填充效率及可靠性。虽然目前市面上有使用免清洗助焊剂进行免清洗工艺,但免清洗助焊剂留下的残留物与底部填充化学之间的兼容性仍然是一个主要问题。兼容性差通常会导致毛细管底部填充流动受阻或底部填充分层。
环氧助焊剂是一种用于倒装芯片封装的新型助焊剂,它的主要成分是树脂(环氧树脂、丙烯酸树脂等)、有机酸活化剂、触变剂和溶剂。在回流焊接过程中其有机组分固化成一层环氧树脂胶,附在焊点周围,起到加强焊点强度、防腐蚀和绝缘的作用,并防止其与底部填充发生化学反应,同底部填充胶、邦定胶等相兼容;环氧助焊剂的固化胶可以在回流焊接过程中进行底部填充,而不需要额外的固化工艺,节省了时间和成本。
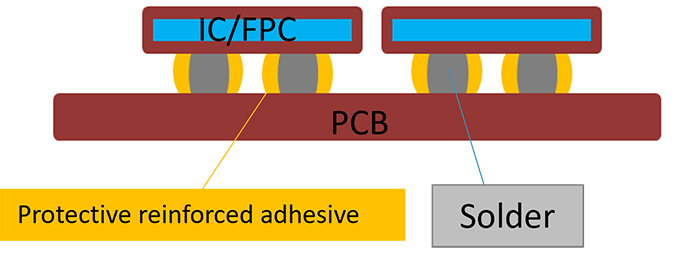
图1. 环氧助焊剂的作用-增强和保护焊点
环氧助焊剂的特点
热稳定性:环氧助焊剂在高温下依然保持较好的稳定性,不易熔化或分解,适用于高温封装工艺。
低挥发性:环氧助焊剂不含卤素,具有较低的挥发性,不会在焊接过程中释放有害气体,符合环保要求。
良好的电绝缘性:由于环氧树脂的绝缘性能优越,助焊剂涂层不仅能提高焊点的机械强度,还能增强焊点的电绝缘性。
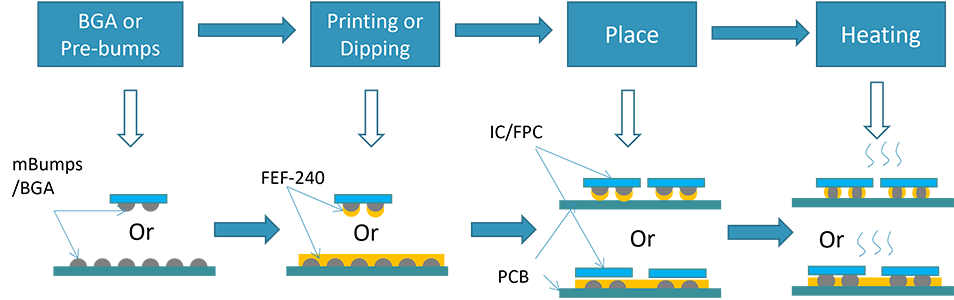
图2. 环氧助焊剂工艺应用-BGA微凸点预置
环氧助焊剂在倒装芯片封装中的应用
1.表面涂覆
在倒装芯片封装中,环氧助焊剂通常被涂覆在芯片的焊点区域。通过精确的印刷或浸渍工艺,确保环氧助焊剂形成均匀的保护层,提高焊点的可靠性。
2.粘结芯片和基板
环氧助焊剂的优良粘结能力使其在倒装芯片封装中用于固定芯片与基板之间的连接。这种连接不仅具有高强度,还能在振动和温度变化等恶劣环境下保持稳定。
3.提高封装质量
通过环氧助焊剂的应用,倒装芯片封装的焊点能够获得更好的机械强度和电气性能,提高封装质量。同时,环氧助焊剂的防氧化作用确保了焊点的长期稳定性。
总而言之,环氧助焊剂在倒装芯片封装上的应用,可以有效地解决传统助焊剂残留物的清洗和兼容性问题,同时提高倒装芯片封装的效率和可靠性,为倒装芯片封装的微型化和高性能化提供了一种有效的解决方案。如果您想了解更多关于环氧助焊剂的信息,欢迎随时联系我们。









 返回列表
返回列表



