使用低温锡铋环氧锡膏提升封装可靠性与效率-深圳福英达

使用低温锡铋环氧锡膏提升封装可靠性与效率
低温锡膏在电子工业中的应用正在逐渐受到关注,尤其是随着集成电路元件的微型化和I/O数量的增加。传统的无铅SAC焊接回流工艺虽然普遍使用,但高温度容易导致可靠性问题,包括工艺良率低、热循环性能差等,这些问题往往与翘曲有关。
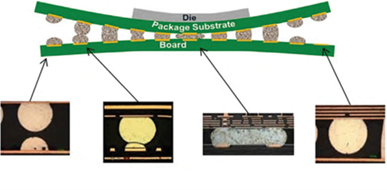
图1. 传统SAC焊料由于焊接温度过高易出现翘曲不良问题
低温锡膏可有效解决翘曲问题,业界通常使用锡铋合金来提高工艺良率、消除枕头效应和提高返工良率。然而,在大多数应用中,锡铋合金的强度通常不足以取代无铅(SAC)和共晶锡铅合金。为了增强锡铋焊点的强度、机械性能和可靠性,一种有效的方法是在锡铋合金焊料中使用环氧树脂代替锡膏中的松香树脂,环氧树脂胶在焊接后残留并固化,起到补强焊点、防护和增强的作用。
环氧锡膏(锡胶)的外观和使用工艺与锡膏基本相同,它同样经过印刷点胶等工艺方式在焊盘上施胶,然后在贴片对位后进行加热焊接。在加热过程中,合金粉末首先熔化收缩,与焊盘形成冶金连接,随后热固胶发生交联反应固化,冷却后完成器件的封装。

图2.环氧锡膏与锡膏工艺对比
环氧锡膏方案简化了封装工序,焊接后无需清洗和填充胶,从而节约了封装工艺时间和成本。该方案非常适用于高密度微细间距,形成微凸点,有效解决了钢网开孔印刷的极限及巨量转移问题。对机械可靠性要求较高的器件封装应用也非常适用。
图3中环氧锡膏(锡胶)焊接剪切强度(与锡膏对比)表明,环氧锡膏焊接后的固化强度不仅包括冶金连接力,还增加了热固胶的胶合力。相同合金条件下,环氧锡膏的剪切强度相对于锡膏可增加20~40%,尤其在微小器件连接方面,这种增强作用更为显著。这有效解决了低温合金锡膏脆性和焊料“吃金”(焊料侵蚀掉镀层)的问题。
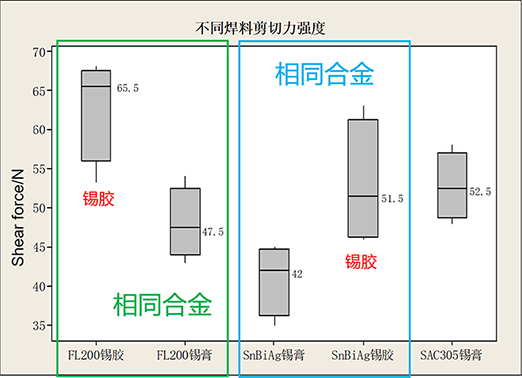
图3.环氧锡膏(锡胶)焊接剪切强度(与锡膏对比)
图4锡胶表面绝缘电阻(与锡膏对比),根据JIS Z3197-2012标准,环氧锡膏在85℃ 85%RH、50V下经过168小时的测试,相对于锡膏在表面绝缘电阻方面表现更优。这进一步证实了环氧锡膏在电子器件应用中具有更出色的性能。
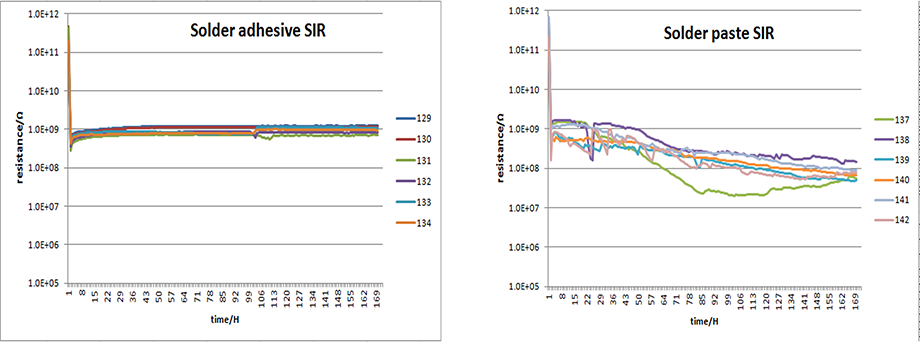
图4.锡胶表面绝缘电阻(与锡膏对比)JIS Z3197-2012:85℃ 85%RH,50V,@168H
总而言之,通过采用低温锡铋环氧锡膏,不仅可以提高焊接工艺的可靠性和效率,还能够适应越来越微小化的电子元件和更高要求的机械性能,为电子工业的进一步发展提供了可靠的解决方案。
深圳市福英达自主研发的环氧锡膏(锡胶)产品包括低温超微锡胶、中高温超微锡胶、Mini LED 专用锡胶和各向异性导电胶,欢迎来电咨询。









 返回列表
返回列表



