SAC305焊料掺入少量SiC后的润湿性怎么样-深圳福英达

SAC305焊料掺入少量SiC后的润湿性怎么样-深圳福英达
SAC305传统的锡膏在焊接的时候金属间化合物(IMC)生长较快,容易形成较厚的IMC层并影响焊点的可靠性。可以知道SiC是一种高熔点陶瓷材料。通过在SAC305中掺入少量的微纳米级SiC颗粒,在焊料熔融固化后SiC停留在焊点本体中,从而可以细化焊点结构并作为金属原子扩散的屏障,使得焊点的界面IMC层生长速度会明显减缓。此外,近年来不少研究人员发现陶瓷颗粒可以改善焊料基体的润湿能力,从而改善焊点微观结构。
SAC305-SiC复合焊料
制备及润湿性验证
Pal等人将平均直径为2μm的SiC掺入SAC305焊料中,用于合成复合焊料。SiC和SAC305粉末在高能球磨中混合约一小时。SiC和SAC305粉末在模具中单轴压实(室温下200Mpa冷压)以形成直径为3mm的圆柱形棒。然后,将样品放入熔炉中进行熔化制成SAC305-1.0%SiC复合焊料。

图1. SAC305-SiC制备步骤。
Pal等人测试在230°C至290°C的不同回流温度下,SAC305-1.0%SiC复合焊料在干净Cu基板上的微观结构发展和润湿性变化。样品在回流下保持约60分钟,在此期间达到润湿性的平衡条件。
实验结果
IMC结构
图2显示了在不同回流温度下回流工艺后SAC305-1.0%SiC/Cu表面的微观结构。在加入1.0 wt%的SiC后,Cu6Sn5和Ag3Sn IMCs出现在Sn焊料基体中但接近界面附近。与Sn接触的层是Cu6Sn5,而Cu3Sn层在Cu6Sn5和Cu之间。随着回流温度从230°C升高到290°C,液/固反应中的Cu6Sn5 IMC层放缓。Cu6Sn5层随着Cu3Sn层的生长而逐渐减小,并且Cu3Sn层随着温度的升高而增加。不可润湿的SiC通常会从熔融焊料中转移出来。界面IMCs的形貌表明,在回流过程中,由于SiC颗粒的偏析而形成孔隙。
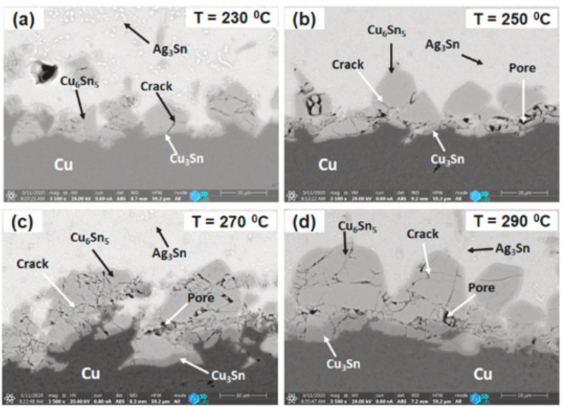
图2. SAC305-1%SiC在不同回流温度的IMC情况。
润湿能力
l 当回流温度为270°C时,SAC305-1.0%SiC焊料的最大相对扩展面积为76 %,比230°C时的最大相对扩展面积大24%左右。随着回流温度升到290°C,最大相对扩展反而降至68%左右。因此可以知道,焊料扩展面积首先随着回流温度的增加而增加,随着温度进一步升高,润湿面积显著减小。
图3. SAC305-1.0%SiC润湿面积和回流温度的关系。 l 在230°C回流温度下SAC305-1.0%SiC焊点的润湿角较大,这表明复合焊料的润湿性较差。随着温度升高,焊点的润湿角开始下降,表面润湿性有所改善。当回流温度进一步提高到290℃,润湿角开始增大。这些结果证实,在特定的回流温度下,可以通过增加SiC颗粒来实现焊料基体润湿性的改善。 表1. SAC305-1.0%SiC在不同回流温度下的润湿角。

参考文献
Pal, M.K, Gergely, G., Koncz-Hoevath, D. & Gacsi, Z. (2021). Investigation of microstructure and wetting behavior of Sn–3.0Ag–0.5Cu (SAC305) lead-free solder with additions of 1.0wt%SiC on copper substrate. Intermetallics, vol.128.









 返回列表
返回列表



