倒装芯片上高熔点焊料与层压基板上低熔点焊料
近几年倒装芯片互联技术已广泛应用于高性能和消费类电子产品。高性能封装已经取得稳步发展,实现了I/O数超过1万个且节距小于200um的互联,实现了陶瓷基板向低成本有机基板转变,实现了无铅焊料替代含铅焊料等。向有机基板转变促使了低熔点焊料取代高熔点焊料。
众所周知,有机材料通常属于环氧树脂系,在超过250℃的温度下不能保持长时间的稳定,避免该问题的一种方法就是在层压焊盘或者芯片的高熔点凸点上趁机低熔点的焊料。如下图所示,芯片上的高熔点焊锡凸点与焊盘上的低熔点焊料形成互连。这种组合允许在与有机层压基板兼容的温度下进行芯片和层压基板的组装。为了确保焊点能够经受层压基板与芯片之间热失配引起的大应变,可进行底部填充。当芯片/下填料/层压基板粘接为一体时,三者同时发生形变,减小芯片与层压基板之间的相对运动,进而减小焊锡凸点的应变。通过芯片上高熔点焊锡凸点与层压基板上低熔点焊料进行互联的封装组件,互联后需进行助焊剂残渣清洗及底部填充。
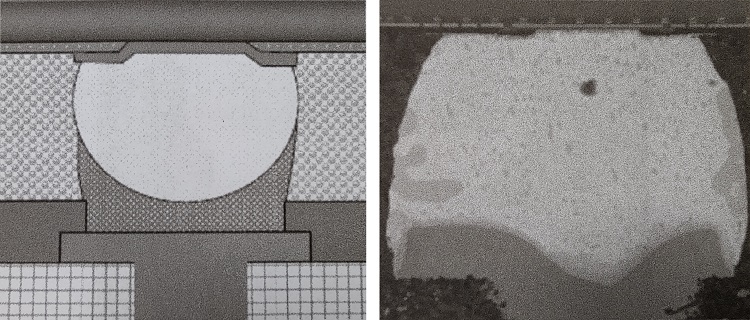
结构示意图&实际焊点的剖面图
若是由Cr/Cu、Cu/Cu组成UBM,当双焊料层经过多次回流时,靠近UBM的焊料基体中Sn含量随回流次数不断增加,加快了与UBM的反应,并最终导致Sn-Cu金属间化合物从UBM基底上完全剥离。解决这一问题可以采用更稳定的反应阻挡层,例如Ni,或者增加Cu层厚度,或者使用针对性进行配方优化的低温焊料,如深圳福英达FL-170低温焊料。
当将倒装芯片粘接到有机层压基板上之后,需彻底清洗助焊剂残渣,并对组装模块进行底部填充和固化,以克服芯片与基板之间的热失配。这样,即使是15mm的大尺寸芯片,也可以通过热循环测试(-45~100℃,1cycle/h)。









 返回列表
返回列表



