实现高可靠性无铅焊点的机械性能
福英达公司-研发中心-罗树全


焊锡的三个基本机械特性包括应力与应变特性、抗蠕变性和抗疲劳性。焊点剪切强度也是体现焊点可靠性的重要因素之一,因为多数焊点在使用期间要经受剪切应力的作用。蠕变在焊点可靠性测试中也是一个很重要的因素,蠕变是当温度和应力都保持常数时造成的整体塑性变形。这个决定于时间的变形可能在绝对零度之上的任何温度发生。可是,蠕变现象只是在“活跃”温度时体现出来。疲劳是指在交替应力之下,焊点可靠性下降甚至失效。疲劳破裂通常从几个小裂纹开始,在应力的循环作用下增加,造成焊接点可靠性下降,元器件焊接失败。在电子封装和装配应用中的焊锡通常经受低循环疲劳和遭受高应力。热力疲劳是用来刻划焊锡特性的另一个测试模式。在电子封装领域中,我们为了确保实现高可靠性焊点,我们应该对焊点的剪切强度和拉伸强度,蠕变等情况进行测试分析。


1.1剪切强度测试
焊点的剪切强度是反应焊点可靠性的一个重要因素,下面是Sn3.5Ag和Sn4.0Ag0.5Cu合金分别在经过OSP工艺和镍沉金(ENIG)工艺的焊盘上的剪切强度测试
[1]
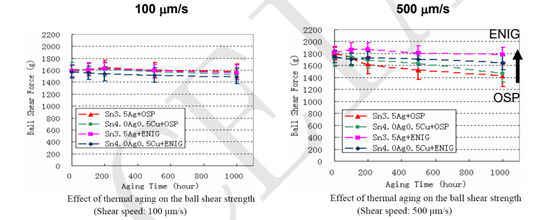
从上图可知,使用不同表面处理工艺的焊盘下合金的剪切强度大小,使用ENIG表面处理工艺≥用OSP表面处理工艺, SAC合金和 SA合金剪切强度也是差不多;经过老化处理对剪切强度产生负面影响;随着老化时间的延长其剪切强度降低。
1.2拉伸强度测试
焊点的拉伸强度是反应焊点可靠性的一个重要因素,下面是Sn3.5Ag和Sn4.0Ag0.5Cu合金分别在经过OSP工艺处理和镍沉金(ENIG)工艺的焊盘上的拉伸强度测试
[2]
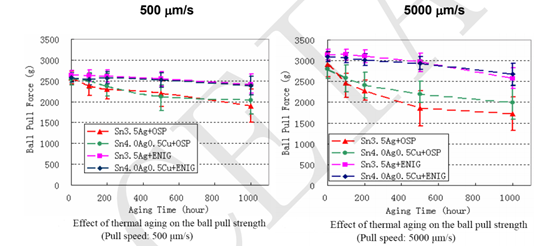
从上图可知,使用不同表面处理工艺的焊盘下合金的拉伸强度大小,使用ENIG表面处理工艺≥用OSP表面处理工艺, SAC合金拉伸强度≥ SA合金拉伸强度;经过老化处理对拉伸强度产生负面影响,测试速度越快其拉伸强度老化越明显。
1.3剪切强度和剪切速度对IMC层厚度的测试
在焊点的IMC层厚度对焊点可靠性有着重要的影响,太厚太薄都会对焊点的稳定性和使用期限造成负面效果。下面是测试焊点剪切强度和剪切速度对IMC层厚度的影响情况
[3]
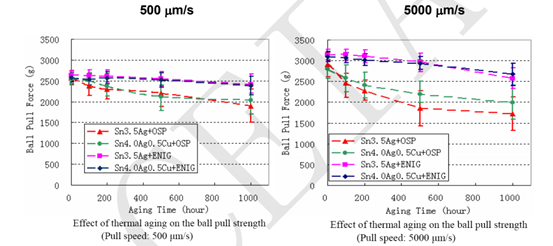
从上图可知,剪切强度测试中,剪切速度越快对IMC层的厚度影响越大;合金成分对IMC层的厚度影响不大。
1.4拉伸强度和拉伸速度对IMC层厚度的测试
焊点的IMC层的厚度是焊点可靠性的重要因素,下面我们测试了拉伸强度和拉伸速度对IMC层的厚度的影响情况
[4]
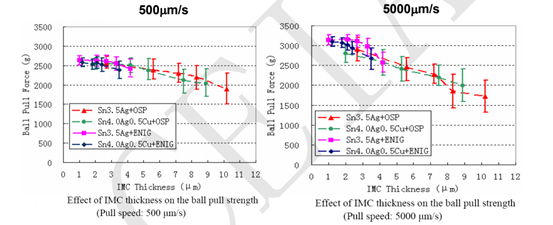
从上图可知,拉伸强度测试中,拉伸速度越快对IMC层的厚度影响越大;合金成分对IMC层的厚度影响不大。
1.5比较剪切强度和拉伸强度对IMC层厚度的影响大小
焊点剪切强度和拉伸强度对IMC层厚度有着重大影响,下面我们测试两种不同合金和两种不同表面处理工艺下剪切强度和拉伸强度对IMC层厚度影响情况
[5]
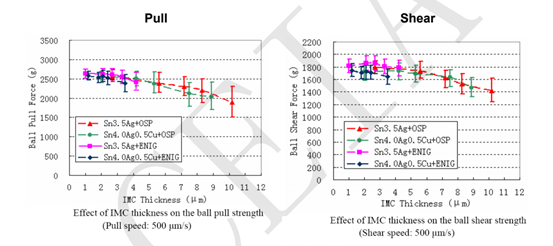
从上图可知,剪切强度和拉伸强度对IMC层厚度的影响大小相当。


2.1倒装芯片接头的蠕变数据
蠕变现象影响着焊点可靠性,下面是倒装芯片接头的蠕变数据
[6][7]

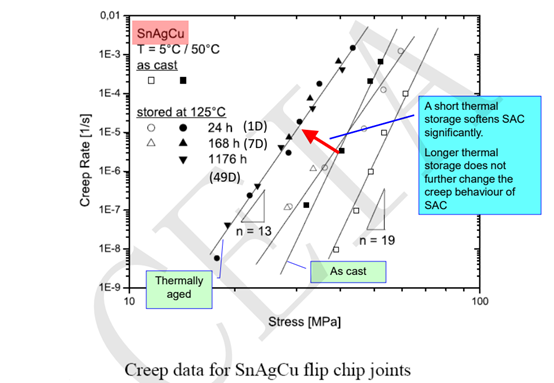
SAC合金蠕变交叉曲线和SnPb合金蠕变交叉曲线测试情况如下图
[8]

蠕变行为在焊点可靠性方面起着负面影响,下面我们进一步分析焊点中蠕变行为的产生过程,焊点形变小,焊点蠕变是慢的;焊点形变大,焊点蠕变是快的。
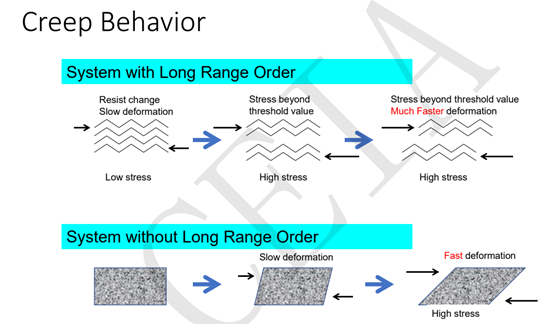
为了焊点可靠性更好,我们应该控制合适焊点的剪切强度和拉伸强度,以及IMC层的厚度,使其达到焊接可靠性要求。电子器件在使用过程中,环境温度会发生变化,由于芯片的功率循环使得周围温度发生变化,而芯片与基板之间的热膨胀系数存在差异,因此在焊点内产生热应力而造成疲劳损伤。同时相对于环境温度,焊料自身熔点较低,随着时间的推移,焊点会产生明显的粘性行为而导致蠕变损伤,造成焊点断裂;外部失效模式则表现为电信号传输失真,即电接触不良、短路和断路。
在一定的条件下,疲劳损伤和蠕变损伤会产生交互的作用,蠕变加速裂纹的形成和扩展,而循环开裂造成的损伤又促进了蠕变的进展,这种交互作用会加剧损伤,使循环寿命大大缩短。而航空航天领域内的电子产品通常处于更恶劣的温度循环条件下,焊点的疲劳蠕变损伤成为电子产品失效的内在隐患。因此如何控制焊点疲劳蠕变损伤成为电子封装领域一个重要课题。
福英达专注于微电子与半导体封装焊料领域20余年,福英达工业科技有限公司是一家全球领先的微电子与半导体封装材料方案提供商,国家高新技术企业,深耕于微电子与半导体封装材料行业,从合金焊粉到应用产品线完整,是目前全球唯一可制造T2-T10全尺寸超微合金焊粉的电子级封装材料制造商。福英达公司锡膏、锡胶及合金焊粉等产品广泛应用于微电子与半导体封装的各个领域。得到全球SMT电子化学品制造商、微光电制造商和半导体封装测试商的普遍认可。但微电子与半导体封装材料问题广泛,在此我们仅就常见问题展开了叙述。因工艺过程不同,其过程中所涉及到的问题也可能不尽相同。欢迎您就具体问题与我们的专业人员进行沟通讨论。我们希望同合作伙伴共同与时俱进,共同探究新问题、新技术以及复杂工艺,努力为合作伙伴提供专业、周到的微电子与半导体封装焊接材料服务。
参考文献
[1]Fubin Song and S. W. Ricky Lee, “Investigation of IMC Thickness Effect on the Lead-free Solder Ball Attachment Strength: Comparison between Ball Shear Test and Cold Bump Pull Test Results”, 56th ECTC Proceedings, P. 1196-1203, San Diego, CA, May 30-June 2, 2006
[2]Fubin Song and S. W. Ricky Lee, “Investigation of IMC Thickness Effect on the Lead-free Solder Ball Attachment Strength: Comparison between Ball Shear Test and Cold Bump Pull Test Results”, 56th ECTC Proceedings, P. 1196-1203, San Diego, CA, May 30-June 2, 2006
[3]Fubin Song and S. W. Ricky Lee, “Investigation of IMC Thickness Effect on the Lead-free Solder Ball Attachment Strength: Comparison between Ball Shear Test and Cold Bump Pull Test Results”, 56th ECTC Proceedings, P. 1196-1203, San Diego, CA, May 30-June 2, 2006
[4]Fubin Song and S. W. Ricky Lee, “Investigation of IMC Thickness Effect on the Lead-free Solder Ball Attachment Strength: Comparison between Ball Shear Test and Cold Bump Pull Test Results”, 56th ECTC Proceedings, P. 1196-1203, San Diego, CA, May 30-June 2, 2006
[5]Fubin Song and S. W. Ricky Lee, “Investigation of IMC Thickness Effect on the Lead-free Solder Ball Attachment Strength: Comparison between Ball Shear Test and Cold Bump Pull Test Results”, 56th ECTC Proceedings, P. 1196-1203, San Diego, CA, May 30-June 2, 2006
[6]Ref: S. Wiese, M. Roellig, K.-J. Wolter, " Creep of Eutectic SnAgCu in Thermally Treated Solder Joints", 55th ECTC, P.1272-1281, May 31-June 3, 2005
[7]Ref: S. Wiese, M. Roellig, K.-J. Wolter, " Creep of Eutectic SnAgCu in Thermally Treated Solder Joints", 55th ECTC, P.1272-1281, May 31-June 3, 2005
[8]Ref: Ahmer Syed, " Accumulated Creep Strain and Energy Density Based Thermal Fatigue Life Prediction Models for SnAgCu Solder Joints", 54th ECTC, P.737-746, June 1-4, 2004, Las Vegas, Nevada.


微电子与半导体超微焊料方案提供商










 返回列表
返回列表



