金锡锡膏焊点微观结构演化-福英达锡膏

金锡锡膏焊点微观结构演化-福英达锡膏
提到无铅锡膏大家最熟悉的肯定是中温锡银铜锡膏和低温锡铋银锡膏。这两种类型的无铅锡膏应用范围很广,且其熔点从139℃-217℃不等,能够满足大部分常规的封装需求。有些领域必须要采用高温焊料。但含铅焊料的使用已不被允许。作为高温含铅锡膏的替代品,共晶金锡锡膏(Au80Sn20)的发展已经有一段时间了,该合金具有优异的抗疲劳性能,高温性能,耐腐蚀性和抗蠕变性。
金锡锡膏是一种很特殊的焊料,具有比传统锡膏更优秀的抗氧化性和润湿性,能够不借助助焊剂在280℃以上完成焊接工作。比如在功率型LED芯片中往往能够见到金锡锡膏的身影。金锡锡膏通常被电镀在硅片上形成Au和Sn薄膜,焊接加热后通过界面反应形成焊点。金锡锡膏与焊盘的界面反应和金属间化合物(IMC)情况影响焊接效果,需要我们了解。
金锡锡膏IMC演变
扩散机制是IMC生成的本质原因。金属原子在焊接时通过扩散作用形成金属间化合物。Au和Sn的相互扩散率很高,在不同温度会产生金属间化合物。通过相图可以知道固态共晶金锡锡膏的IMC主要包括Au5Sn和AuSn。
Tsai等人在Cu基板和Ni基板上蒸镀沉积Au80Sn20锡膏形成Sn/Au/Cu和Sn/Au/Ni夹层结构并研究了焊盘界面处微观结构演变。当在290℃焊接2分钟时,发现在Ni基板界面都会生成(Au, Ni)5Sn和(Au, Ni)Sn。对Ni基板而言,界面的金属化合物层虽然都为(Au, Ni)5Sn和(Au, Ni)Sn,但是分布位置却对调了(图1)。
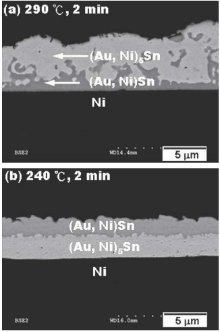
图1. Sn/Au/Ni焊接微观结构 (a)(Au, Ni)Sn靠近Ni一侧; (b) (Au, Ni)5Sn靠近Ni一侧。
焊接后的Cu基板处金属化合物是以(Au, Cu)5Sn和(Au, Cu)Sn为主(图2)。可以知道有少量的Cu融入了Au的子晶格中。并且可以发现在不同温度下,(Au, Cu)5Sn层中的Au和Cu的比重并不一样。低焊接温度使得Cu含量更低。
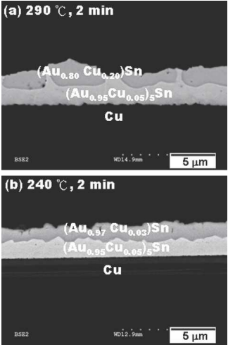
图2. Sn/Au/Cu焊接微观结构。
老化后焊点微观结构
锡膏-Cu界面
金锡锡膏焊点的微观结构演变机制相当复杂且规律难寻,这和锡银铜和锡铋银焊点微观结构区别很大。比如Sn/Au/Cu焊点在240℃焊接并在该温度下老化1小时后,(Au, Cu)5Sn和(Au, Cu)Sn都发生了变化。(Au, Cu)5Sn从(Au0.95, Cu0.05)5Sn变成了(Au0.7, Cu0.3)5Sn和(Au0.6, Cu0.4)5Sn。(Au0.97, Cu0.03)Sn变成了不连续的(Au0.94, Cu0.06)5Sn,这情况表明Cu在焊料中的融解显著的增加。
在240℃老化10小时后,(Au0.94, Cu0.06)Sn没有变化。但是出现了Cu3Au和无法确定成分的Au-Cu-Sn。虽然成分有小变化,总体来看,(Au, Cu)5Sn总是更倾向挨着Cu层生长。
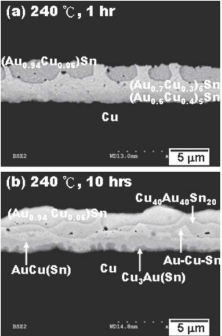
图3. 240℃焊接和老化后Cu界面微观结构。
锡膏-Ni界面
可以发现在老化1000小时后Ni界面仍然保持较为完整的结构。(Au, Ni)5Sn层依旧保持连续性。(Au, Ni)Sn层消失,取而代之出现了(Ni0.6, Au0.4)3Sn2和少量的不确定成分的Ni-Au-Sn。紧挨着Ni层出现(Ni0.6, Au0.4)3Sn2表明有一定量的Au融解。
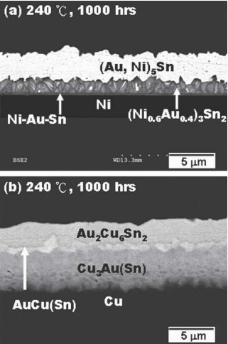
图4. 240℃焊接和老化后Ni界面和Cu界面微观结构对比。
客户如果有高温无铅锡膏产品的需求,可以与深圳市福英达联系。深圳市福英达有着先进的金锡锡膏生产技术,产品能够满足高温焊接的需求。
参考文献
Tsai, J.Y., Chang, C.W., Ho, C.E., Lin, Y.L. & Kao, C.R. (2006). “Microstructure Evolution of Gold-Tin Eutectic Solder on Cu and Ni Substrates”, Journal of Electronic Materials, vol.35(1).









 返回列表
返回列表



