单片机封装(SCP)介绍-福英达锡膏

单片机封装(SCP)介绍-福英达锡膏
单片机封装(SCP)是一种较为简单且非常普遍使用的封装模式,已经有了很丰富的经验。SCP通过将单个芯片进行封装从而形成一个微电子设备,往往封装材料由低成本的塑料和高热性能和可靠性的陶瓷制成。SCP器件从切割晶圆开始,然后对单个芯片进行封装和老化测试,在结果合格后可投入生产。
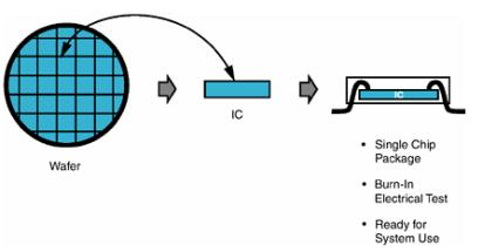
图1. 单片机封装基本流程。
单片机封装方法
芯片的电信号连通需要通过邦定来实现。需要将芯片通过一些方式固定到特定的基板上,例如引线键合,倒装芯片键合,焊料连接或导电胶连接。引线键合是目前应用最广泛的一种邦定方式,通过使用金线或铝线等延展性导电性好的金属来连接芯片电极和基板焊盘。倒装芯片键合能够实现高I/O数量。在倒装芯片键合中,芯片周边会涂覆上锡膏,或者在芯片焊盘上植球形成微凸点。凸点管芯面朝下翻转并与基板上预形成焊盘相贴合。互连基板可以是PCB,陶瓷材料,芯片载体或球栅阵列封装。
为了进一步改进电子器件的性能,集成电路的水平进步的越来越快,这就需要在封装中实现大量的I/O数量。为了满足这些需求,封装空间内就需要具有更多的引脚和更小的间距。由此诞生出很多封装结构。
双列直插式封装 (DIP)
DIP是一种常见单片机封装结构,在DIP的两侧焊有引脚。这些引脚能够插入到PCB的镀通孔中实现电通路。DIP的引脚数量不多,通常在8-64个引脚。更多的引脚较为少见。芯片通过引线与引线框键合,引线框外延形成引脚。生产商往往采用塑料,环氧树脂或陶瓷对芯片进行封装。在PCB通孔上涂上锡膏后可以将引脚插入,焊接后锡膏固化成为焊点。
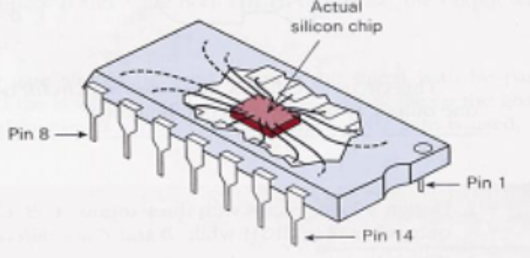

图2. DIP结构。
方形扁平封装(QFP)
QFP可以是金属或陶瓷型腔封装,也可以是塑料模制封装。引脚从四个侧面延伸出来。QFP引脚数远远多于DIP,最多可以有300多个。QFP可允许在一个封装体中封装单芯片或多个芯片,能够用到更高集成度的设备中。QFP的引脚会被弯曲形成为鸥翼形状,并贴装在基板的焊盘位置上,这一点与DIP有着巨大不同。贴装邦定材料通常采用锡膏,在回流后锡膏固化成为焊点。

图3. QFP外观。
球栅阵列 (BGA)
BGA目的是在完成芯片的一级封装后将器体焊接在PCB上。BGA技术出现是由于其他老式封装(如QFP)的I/O数量已经达到了瓶颈,因此需要更先进的封装技术实现更多I/O数量。BGA的封装形式和倒装键合类似,都通过植球并回流焊接生成焊点。BGA是一种很灵活的封装形式。既可以在封装内部实现引线键合,也能够满足倒装需求。芯片可以引线键合与基板焊盘连接也可以植球倒装与焊盘结合,然后进行封装。封装后在单片机底部裸露焊盘上植球后焊接在PCB上。尽管BGA封装的凸点数量很多且I/O间距变大,但总体的尺寸依旧很小。
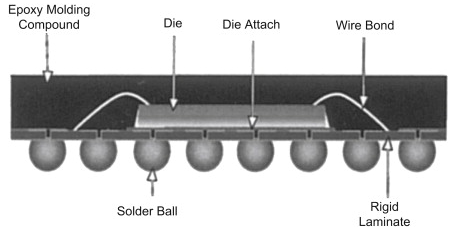
图4. BGA示意图。
针栅阵列 (PGA)
PGA也是一种很传统的封装技术。PGA的形状为矩形或方形,底部带有若干排引脚或者有一个完整的引脚阵列。和DIP相似,PGA主要通过插装安装在PCB上。PGA比DIP更适合具有更大宽度数据总线的处理器,因为PGA可以提供更多的引脚数量并更好地处理特定数量的连接点。在价格上PGA要比BGA或其他管脚阵列便宜,但是PGA的热电性能不足以满足更高的需求,应用范围要小于BGA等。
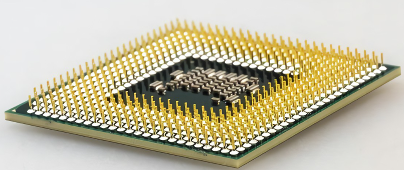
图5. PGA外观。
深圳市福英达可谓客户提供超微锡膏产品,包括SAC305锡膏,Sn42Bi57.6Ag0.4锡膏等,能用于元器件的插装,表面贴装和回流焊接工艺,还可用于印刷制造锡膏点从而替代BGA植球。









 返回列表
返回列表



