BGA锡膏和BGA植球工艺类型-深圳市福英达

BGA锡膏和BGA植球工艺类型-深圳市福英达
随着大规模集成电路的快速发展,传统封装技术如通孔插装无法满足高密度封装的需求。而出于高集成度,小封装尺寸和更多I/O数量的需求,新的封装工艺应运而生。球栅阵列(BGA)封装突破了传统封装的限制,目前是应用领域广泛的一种新封装技术。BGA植球常见的类型有激光植球,印刷植球,手工植球和移印植球。
激光植球法
激光植球多用于小批量植球生产中,操作简单且工艺流程短。激光植球的机理是将锡球放入激光植球机中。植球机内部激光加热将锡球单独回流熔化成液态,然后液态锡通过喷嘴滴落到BGA焊盘上完成植球。激光植球需要通氮气保护,避免回流时发生氧化现象。
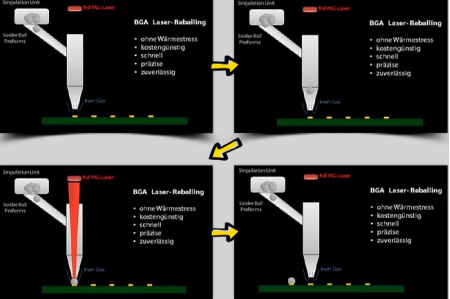
图1. 激光植球工艺。
印刷植球方案
印刷植球和SMT锡膏印刷过程相似,都需要用到钢网。印刷植球工艺需要将小钢网对位并定位到BGA焊盘上,然后进行锡膏印刷作业,而不是使用预成型焊料球。经过回流后锡膏固化收缩成为锡球。印刷植球的缺陷是锡球均匀性有限,共面性不足。T6及以上的锡膏具有小粒径的特点,能够取代预成型锡球用于小尺寸BGA植球。
锡膏印刷工艺是无铅锡膏从钢网转移到焊盘的过程,涉及钢网,锡膏和自动印刷机。锡膏印刷工艺对印刷植球可靠性影响很大。在确认了BGA植球所需锡膏量后,需要定制合适开孔布局的钢网。测定BGA植球所需锡膏量通常需要考虑以下因素。
1. 锡膏量充足以确保良好的BGA尺寸。
2. 选择焊膏量应考虑BGA元件的焊球共面误差(通常为0.1mm)。
3. 当电路板上有其他细间距组件时,应综合考虑锡膏量,以防止出现更多的焊接缺陷。
手工植球法
手工植球不适合大规模生产,一般用在BGA返修植球或打样植球。手工植球需要用到小钢网。钢网对位到焊盘位置并将锡球放置在网孔中。在移开钢网后进行回流加热将锡球熔化完成植球。
移印植球工艺
移印植球是实现BGA大批量,高效率植球的成熟工艺,在数秒内就能完成上万颗锡球植球。移印植球的流程大致可分为以下几个步骤。
1. 将BGA焊盘朝上放置在传送轨道上。根据厂家的生产能力,一次植球的数量为4-20颗BGA。
2. 根据BGA要求选择特定的针管。如果每颗BGA有1000个锡球,则每区块针管阵列由1000个针管组成。如果植球4颗BGA,则需要用到4个针管阵列(4000个针管)。针管的作用是沾取助焊膏并转移移印到4颗BGA对应的焊盘上。移印完成后将BGA传送到下个环节。
3. 将BGA锡球堆叠在针管上并通真空。每个针管吸取一颗锡球并对准移印了助焊膏的BGA焊盘,然后关闭真空并吹气将锡球放置在焊盘上。完成锡球放置后将焊盘进行回流加热,锡球熔化完成植球。
深圳市福英达的超微锡膏(T6及以上)适用于BGA植球工艺。福英达超微锡膏产品在回流焊接后形成的锡球尺寸合适,光滑度高,机械强度优秀,能够很大程度取代预成型焊料球。









 返回列表
返回列表



