高温金锡焊料微凸点制备及可靠性-深圳福英达

高温金锡焊料微凸点制备及可靠性-深圳福英达
目前在封装焊料界最为常见和成熟的锡膏类焊料种类大致就三种。一种是以锡铋银为基础的低温锡膏(熔点138℃左右),另一种是以锡银铜为基础的中温锡膏(熔点217℃左右)。还有一种锡锑锡膏(熔点245℃左右),能满足更高熔点的要求。为了实现比锡锑锡膏更高的熔点要求,封装材料界发明了金锡焊料。共晶金锡焊料(Au80Sn20)的熔点达到了280℃,能够用在一些对焊接温度要求很高的电子产品,如高功率电器,航空航天设备等。金锡焊料涂覆方法有预成型,锡膏印刷/点胶,电子束蒸发和焊料电镀。
金锡焊料电镀法是一种很有吸引力的焊料涂覆方法,有着成本低,速度快,易操控的优点。电镀工艺是使用单独的Sn和Au溶液,依次在基板上电镀Sn和Au层。为了避免焊盘Cu原子扩散太快,可以在Si晶片上采用Ni作为凸点下金属层(UBM)。在电镀完成后进行回流焊接形成微凸点。电镀金锡焊料的完整流程如下图所示。
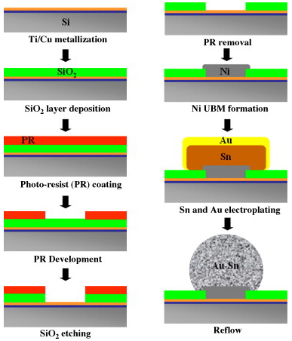
图1. 金锡焊料制备微凸点流程。
Yoon等人先将Si晶片进行Ti/Cu金属化,然后沉积SiO2钝化层并制备Ni UBM。最后在Si晶片上单独制备Sn和Au电镀层并回流生成金锡焊料凸点。凸点最后会进行老化和冲击剪切测试。样品在150℃下高温储存老化1000小时。剪切试验的剪切速度为100μm/s,剪切高度为20μm。
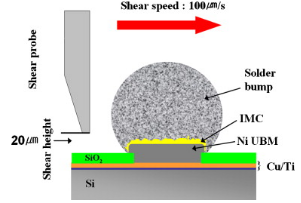
图2. 凸点剪切试验示意图。
Yoon等人通过SEM看到金锡焊料凸点在150℃老化后主要形成金属间化合物(IMC)Au5Sn(浅灰)和AuSn (深灰)。由于Ni在AuSn中的溶解度较高,因此在Ni UBM界面形成了Au-Ni-Sn化合物。此外可以清楚看到IMC的厚度随着老化时间增加而增加。随着时间增加AuSn大量沉积在Au-Ni-Sn上方。
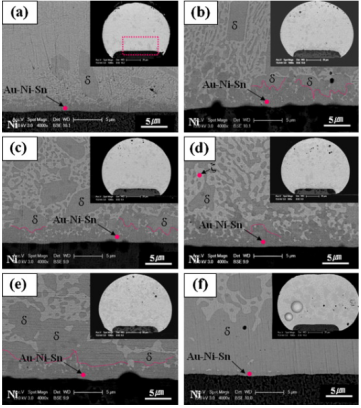
图3. 150℃老化不同时间后Au80Sn20/Ni界面的SEM图。(a)0h, (b)48h, (c)100h, (d)250h, (e)500h, (f)1000h。
老化时间并不会对金锡焊料凸点的剪切力造成显著影响。凸点剪切力在刚回流后到老化100小时内呈现上升趋势,剪切力在老化100小时的时候达到最峰值。随着老化时间增加,剪切力略微下降。通过剪切断裂表面可以知道断裂失效主要发生在Ti/Cu和Ni UBM的界面处。因此金锡焊料的强度要高于Ti/Cu和Ni UBM结合强度,可靠性优秀。
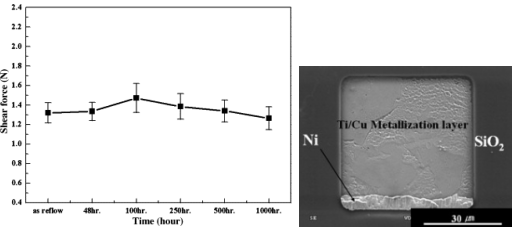
图4. 凸点剪切力变化和老化1000小时后的断裂表面。
金锡焊料不仅能用电镀方法进行涂覆,还能制成金锡锡膏印刷或点胶涂覆到基板上。对于金锡锡膏产品的生产,深圳市福英达有着丰富的经验和先进的生产技术支撑。福英达的金锡锡膏熔点为280℃,印刷性/点胶性能稳定,焊后机械强度和导电性优秀,能够用于高可靠性焊点制备。欢迎与我们联系合作。
Yoon, J.W., Chun, H.S.& Jung, S.B. (2008). Reliability evaluation of Au–20Sn flip chip solder bump fabricated by sequential electroplating method with Sn and Au. Materials Science and Engineering: A, vol.473(1-2), pp.119-125.









 返回列表
返回列表



