ENIG镀金层对SAC305锡膏焊接的影响-深圳市福英达

ENIG镀金层对SAC305锡膏焊接的影响-深圳市福英达
为了保护PCB焊盘免受氧化影响,往往需要进行表面镀层处理。ENIG是一种高效的表面处理手段,通过依次在焊盘上镀上镍层和金层,很大程度起到抗氧化作用。业界对镀镍层的普遍共识是镍可以有效地减缓Sn原子和Cu原子的扩散,从而减少金属件化合物(IMC)的厚度。不少人认为镀金层会影响焊料在焊盘上的润湿性,但相关研究较少。
为了深入了解ENIG镀金层的厚度对润湿性的影响,Wang等人使用了SAC305锡膏在ENIG-Cu焊盘上进行了回流焊接测试,并分析Au层厚度对焊接效果的影响。测试焊盘上的Ni层厚度为5μm。Au层的厚度为30nm,50nm和80nm。
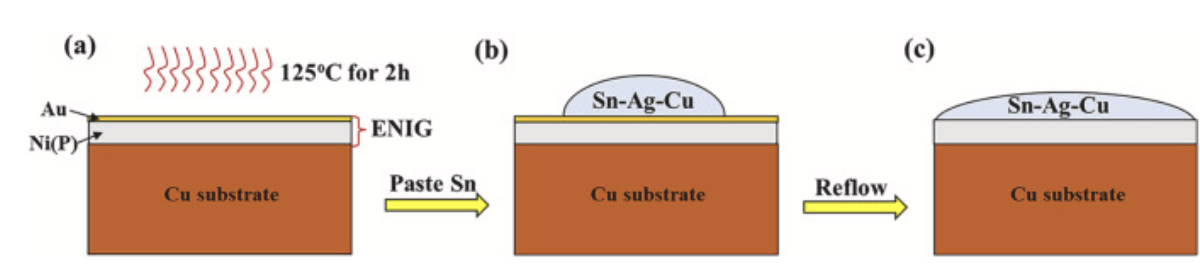
图1. 测试SAC305焊接过程。
测试结果
通过使用XPS检测,发现前期125℃热处理时Au层的表面出现了Ni和Ni的氧化物。理论上说在ENIG的Au层表面不会出现Ni,但Wang等人在实验中发现在热处理后的Au层表面发现了Ni含量的增加。此外Au层表面的Ni氧化物主要以Ni(OH)2和NiO为主。值得注意的是随着Au层厚度的增加,Ni(OH)2和NiO的含量有所减少。当Au层厚度为30nm时,Ni含量大约为6.7%。随着Au层的厚度增加至80nm,Ni含量降低至4%。
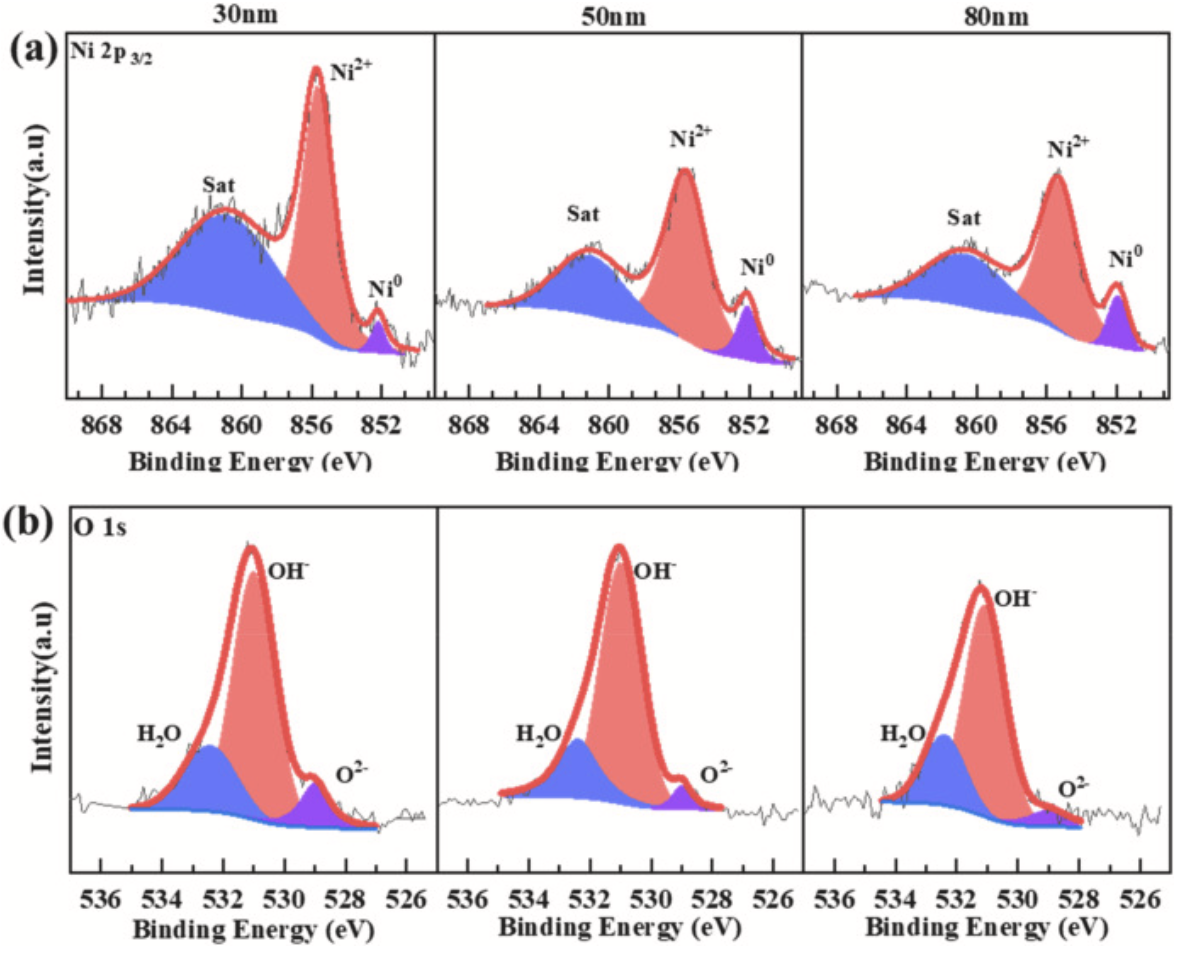
图2. ENIG表面XPS光谱图 (a) Ni 2p 光谱 (b)O 1s 光谱。
Au层表面出现Ni的机理
对于ENIG来说,Au层不仅保护焊盘不受氧化,同时也保护Ni层不受氧化。然而,由于原子半径差(RNi=1.25Å和RAu=1.44Å)的原因,使得Ni原子在受热时有机会沿着原子间隙扩散到Au层的表面。一旦热处理暴露在空气中,扩散到Au表面的Ni会氧化成Ni(OH)2和NiO。
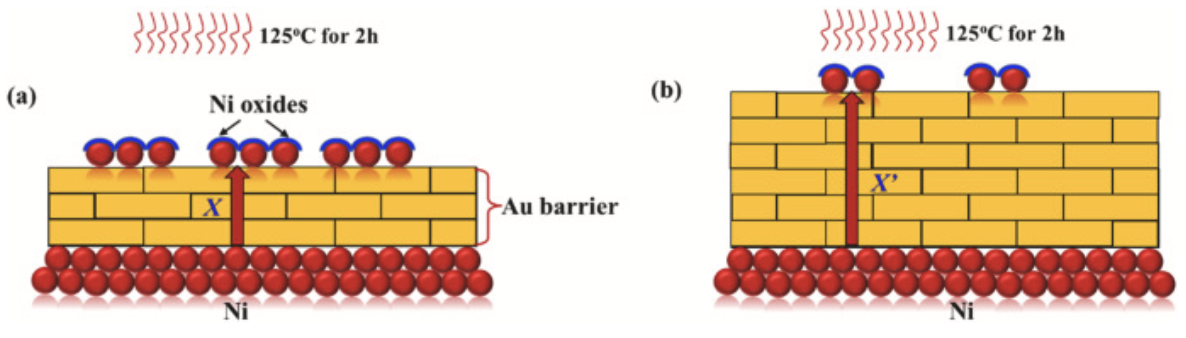
图3. Ni扩散及氧化示意图。
Au层对润湿性影响
当Au层厚度增加时,焊料能够更顺利得在焊盘上铺展,意味着焊料对焊盘的润湿性更强。这是因为Au层厚度增加能减少镍氧化物的形成,从而保障了焊料的润湿能力。
深圳市福英达能够生产润湿性优秀的超微锡膏产品(T6及以上),能够适用于各种表面处理的PCB上。不仅于此,福英达锡膏的粒度分布区间窄,抗坍塌性能好且焊后机械强度高。欢迎客户与我们合作。


参考文献
Wang, J., Sun, Q., Tang, X.X. & Akira, K. (2022). Influence mechanism of Au layer thickness on wettability of Sn–Ag–Cu solder on heated ENIG pads. Vacuum, vol.201.









 返回列表
返回列表



