超薄3D-IC封装在制造过程和温度循环测试耦合负载影响下的可靠性评估-深圳市福英达

超薄3D-IC封装在制造过程和温度循环测试耦合负载影响下的可靠性评估
为应对物联网和智能制造,基于摩尔定律的半导体芯片结构设计涉及相关电子元器件尺寸的缩小。因此,晶体管的密度逐渐增加。为实现上述封装要求,解决传统封装框架的瓶颈,现有研究以堆叠方向的三维互连为主流技术。关键技术是硅通孔 (TSV) 和焊料微凸块 (μbump) 的互连,这通常是失效位置方面的关注领域。三维集成电路(3D-IC)封装在制造工艺和可靠性方面的诸多挑战需要克服,其中加速热循环测试(TCT)的可靠性问题尤为关键。根据 JESD22-A104D 规范,封装组件之间的剧烈热膨胀系数(CTE) 不匹配会在热负载下对关键焊料 μbump 产生明显的热应力 。
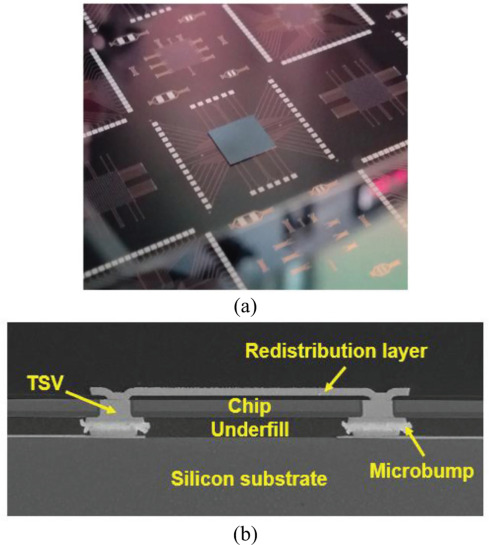
图 1. 实际超薄型芯片3D-IC封装
Garofalo-Arrhenius蠕变模型
当材料在高于熔点 0.5 T m的温度下承受固定载荷时,应变随时间增加。这种现象称为蠕变。图 2表明,韧性材料在固定应力和温度下的蠕变行为可分为三个阶段,即初级、二级和三级蠕变。稳态区占蠕变变形的大部分。对于应用于电子封装的焊点,Garofalo-Arrhenius 模型,也称为双曲正弦模型,被广泛用于定义蠕变行为。图 2所示的第二阶段呈现稳态蠕变,由 Garofalo-Arrhenius 模型描述。

图2. 固定应力下焊料合金蠕变应变与时间的关系。
表1列出了本 FEA 中使用的详细材料属性。为了准确预测 SnAg μbump 的蠕变行为和封装翘曲,我们将非线性材料属性分配给焊料和铜 [ 34 ]。焊料表现出与温度相关的特性和蠕变行为。表 2列出了 SnAg 焊料的 Garofalo–Arrhenius 蠕变模型的系数。由于热循环负荷的最高温度(125℃)超过成型材料的玻璃化转变温度(Tg)(110℃),成型材料的杨氏模量大大降低,从而影响了成型材料的机械性能整个包裹。因此,在目前的 FEA 中,应考虑 Tg 作为成型材料。
表 1.当前 3D-IC 封装 FEA 中使用的材料属性列表。

表 2. 96.5Sn3.5Ag 焊料的 Garofalo–Arrhenius 模型参数 [ 32 ]。

由于相关组装过程中的巨大温度变化,往往会在封装结构内诱发对可靠性产生相当大影响的残余应力。在这项研究中,通过阐明所提出的耦合载荷的问题和影响,预测了 TCT 之前封装设备的实际机械状态。 3D-IC封装的超薄芯片制造工艺是将填充铜的 TSV 芯片粗磨至 100 μm,并调整其与硅基板的连接。在 250 °C 的热压下,芯片和基板粘合在一起,形成 15 μm 的间隙,然后通过毛细管作用填充底部填充材料。此后,在芯片上涂上较厚的成型材料,以分散芯片的磨削载荷,从而避免在将 100 μm 厚的芯片进一步磨削至 10 μm 厚度时发生芯片断裂。然后将钝化层沉积在组装芯片的顶面上。由于相对于 TCT 持续时间的时间限制,在制造过程的模拟中忽略了 μbumps 的蠕变行为。本文采用的 TCT 条件遵循 JEDEC 标准 JESD22-A104 条件 D。温度范围介于 −40 °C 和 125 °C 之间。从 25 °C 的室温加热到 125 °C 需要 450 秒。然后将 125 °C 的温度保持 900 秒。温度随后在 900 秒内从 125 °C 降至 -40 °C。最终,温度在 450 秒内恢复到 25°C。一次 TCT 持续 3600 秒。在这项工作中,在 FEA 中执行了七个完整的 TCT,以获得关键焊料 μ 凸块的收敛、增量和等效塑性和蠕变应变。
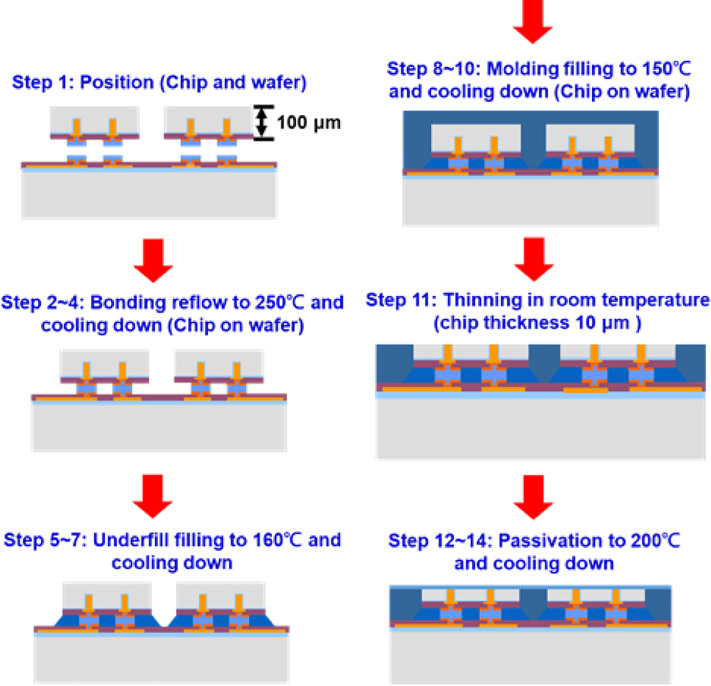
图 5. 所提出的 3D-IC 封装超薄芯片的制造工艺示意图。
图 6显示了制造过程和 TCT 的耦合载荷影响的增量和等效塑性和蠕变应变。峰值应变出现在温度恢复到室温的过程的后期,因为此时在封装组件中引入了最显着的CTE失配。以第 12 步的情况为例,其中结构刚度因切屑变薄而降低。当封装加热到 200 °C 时,估计会出现明显的增量塑性应变峰值和等效塑性应变峰值。此外,分析结果表明,在七次 TCT 之后,μbumps 的增量和等效蠕变应变几乎与它们的增量和等效塑性应变相同。因此,在评估 TCT 的可靠性时,不能忽视 SnAg 焊料 μbumps 的蠕变效应。图 7显示了整个封装结构在每个制造步骤和 TCT 中的翘曲变化。第 12 步的严重翘曲可归因于临界变形的增加,该变形引起相应的增量和等效塑性应变。此外,TCT 相对于制造部分引起的翘曲变化相当小。也就是说,在后续TCT的可靠性评估中需要考虑制造过程中残余应力的影响。


图 6.TCT的耦合载荷下,最外层焊料 μbumps 的估计等效塑性和蠕变应变增量的变化。


图 7.基于所提出的仿真方法的预测, 3D-IC 封装的超薄芯片在处理步骤和后续TCT下的翘曲变化。
5.1.组装芯片厚度
如图8所示。随着切屑厚度增加到大于 ~20 μm,应变增量增加。这种现象随着使用具有高杨氏模量的底部填充材料而变得广泛。在 20 和 50 μm 之间的芯片厚度过渡处,芯片显示出最小的结构弹性性。因此,影响 μbump 可靠性的主要机制是底部填充材料和 PBO 材料之间的 CTE 不匹配。然而,随着采用刚性厚度层,填充铜的 TSV 与芯片之间的热失配会增加。因此,在制造过程和 TCT 的负载下,μbumps 会积累并维持较大的剪切应变。这种情况导致非弹性应变增加。相比之下,当具有低杨氏模量的底部填充物用作应力缓冲层以分散μbump的剪切变形时,可以减少μbump的应变增量。

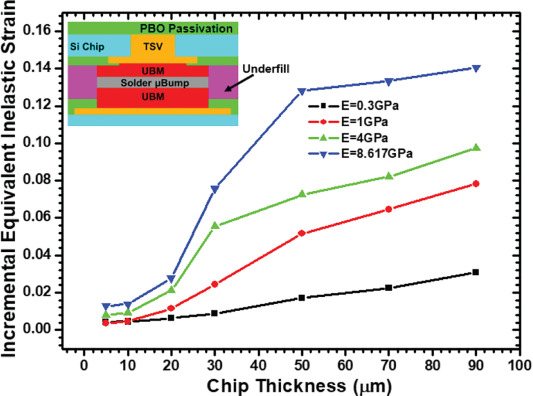
图 8.考虑具有不同杨氏模量值的底部填充时,芯片厚度对临界 μbump 上等效非弹性应变增量的依赖性。
5.2.TSV间距效应
如图 9所示当 TSV 间距从 170 μm 扩展到 250 μm 时,等效非弹性应变增量略有下降。原因可以归因于这样一个事实,即不同材料之间的 CTE 不匹配引起的应变可以均匀地分布到每个焊料 μbump。然而,随着应用各种底部填充物,观察到应变幅度的显着差异。结果表明,在保持相同间距的情况下,具有较低底部填充杨氏模量的 μbump 的应变增量会减小。因此,设计的参数,即底部填充的杨氏模量,在减小 μbump 应变方面比 TSV 间距更敏感。分析结果表明,具有 0.3 GPa 杨氏模量的底部填充是减少临界 μbump 应变累积的良好选择。

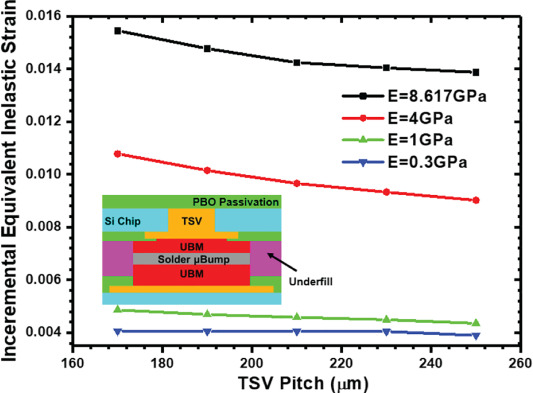
图9. 底部填充胶的四种不同杨氏模量被考虑时, TSV 间距对 μbump 非弹性应变增量的依赖性。
5.3.TSV半径效应
对于TSV半径的参数化分析,估计结果如图10所示。与之前关于其他参数的讨论类似,当 TSV 的半径尺寸固定时,底部填充胶的低杨氏模量会导致 μbump 的应变增量较低。 TSV 半径的增加通常会导致较大的应变增量。尽管如此,具有 25 μm TSV 半径和杨氏模量为 4 和 8.617 GPa 的底部填充的组装芯片降低了 μbump 应变。因此,估计结果表明 TSV 半径与 μbump 的应变增量有关。当 TSV 半径从 10 μm 扩展到 25 μm 时,与 PBO 材料的接触面积也会扩大。由于封装组件之间的 CTE 不匹配导致的严重变形会增加 μbump 应变。除了凸点下冶金层(UBM)外,还包裹焊料 μbump 的底部填充物具有较低的杨氏模量,可提高结构的柔韧性。因此,可以大大降低上述应变。当 TSV 半径为 25 μm 时,连接在焊料 μbump 上方的 UBM 层具有相同的直径,并且 μbump 内的应变也会增加。使用杨氏模量为 4.0 或 8.617 GPa 的底部填充胶可以有效地抵抗 μbump 应变。因此,研究了 μbump 应变增量的下降。与杨氏模量为 0.3 或 1 的底部填料的观察结果相反,杨氏模量为 4.0 或 8.617 GPa 的底部填料抑制封装翘曲的能力非常有限,尽管此时仍可以释放 μbump 应变。因此,最终应变略有增加。
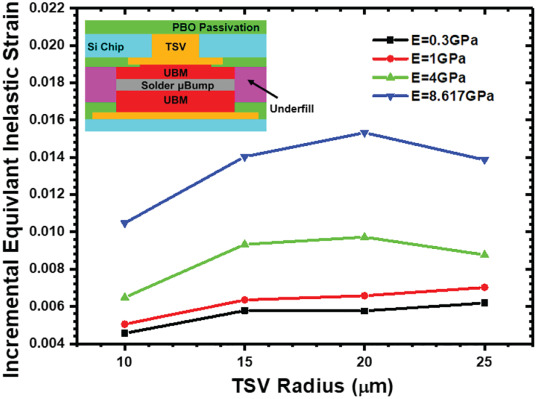
图 10. 当考虑底部填充的几个杨氏模量时,TSV 半径对 μbump 非弹性应变增量的依赖性。
结论
分析结果表明,由于温度相对于TCT温度的剧烈变化,封装结构在加工阶段发生了严重的翘曲。在 TCT 之前几乎达到会聚扭曲。此外,在制造过程中,塑性应变会在焊料 μbump 内大量累积。这种情况导致 TCT 期间塑料积累的减少。尽管如此,应考虑蠕变行为,因为 μbump 的蠕变应变通过 TCT 载荷达到其自身非弹性应变累积的一半。
关于参数分析,估计结果表明,相对较薄的芯片可以获得良好的结构柔韧性,以释放焊料 μbump 的应变。延长 TSV 间距也有利于分散传输到 μbump 的 CTE 失配变形,从而获得低应变增量。至于 TSV 半径,发现较大的半径会导致填充铜的 TSV 和 PBO 层之间的接触面积增加。因此,临界 μbump 的应变增加主要是因为封装材料的严重 CTE 变形。此外,选择具有低杨氏模量的底部填充材料,被视为一种应力缓冲机制,是满足焊料μbumps可靠性要求的好方法。
深圳市福英达能够生产润湿性优秀的超微锡膏产品(T6及以上),能够适用于各种表面处理的PCB上。不仅于此,福英达锡膏的粒度分布区间窄,抗坍塌性能好且焊后机械强度高。欢迎客户与我们合作。


参考文献
Chang-Chun Lee, Yu-Min Lin, Hou-Chun Liu, Ji-Yuan Syu, Yuan-Cheng Huang & Tao-Chih Chang(2021). Reliability evaluation of ultra thin 3D-IC package under the coupling load effects of the manufacturing process and temperature cycling test. Microelectronic Engineering, vol. 244-266.









 返回列表
返回列表



