锡膏焊点的热迁移现象-深圳福英达

锡膏焊点的热迁移现象-深圳福英达
热迁移的成因之一是由于由合金内部温度不一致所致。当在热处理一个均匀的二元合金的时候,由于合金一端和另一端会出现温差,金属原子会发生迁移,合金将变得不均匀。不仅仅热传导会造成热迁移,合金内部的原子扩散也是热迁移的成因。我们目前在一些半导体应用中仍能看到二元合金锡膏的使用,如SnAg,SnCu,SnPb锡膏等。这些无铅锡膏中的Ag,Cu等合金元素在Sn的间隙中扩散。快速的间隙扩散将增强热迁移的通量。
Cu在Sn基体中的间隙扩散非常快,尤其是受到大的热梯度驱动。图1(a)和(b)展示了在电迁移和热迁移测试之前的SnAg焊点。可以发现Cu6Sn5与Cu UBM结合较好。凸点1和4在没有施加电流情况下被加热到150℃,而另选两个参照凸点施加了0.55A电流。结果发现四个凸块经历了几乎相同的焦耳热,这是因为因为硅晶具有良好的热传导。在施加电流应力76小时后,观察到凸点中的Cu6Sn5 IMC在热迁移后迁移到基板端。图1(c)和(d)分别显示了热迁移测试后凸点1和4的微观结构变化。可以发现Si芯片上的Cu UBM几乎完全消失。
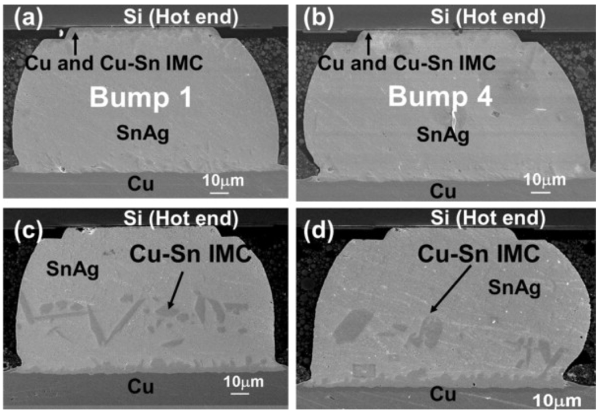
图1. Cu在Cu/SnAg/Ni焊点上的热迁移。(a)(b)未进行热迁移测试; (c)(d)热迁移测试后。
Ni在锡膏焊料中的低溶解度也减缓了Ni原子热迁移的发生。有研究者发现,在250°C下,Ni在无铅焊料中的溶解度仅为0.28wt%,其溶解度比Cu的溶解度小得多。因此在芯片上沉积Ni UBM通常可以作为减缓Cu热迁移的屏障。
通过研究共晶SnAg焊点可以发现,在施加电流前焊点内部结构均匀。随着通入交流电0.57A,焊点内部的焦耳热产生了2829℃/cm的热梯度。在施加电应力300小时后,纯Sn的小丘开始出现在上方的Si芯一侧(热端)。随着应力时间增加到550h,Si芯一侧Sn的体积开始变大。当应力时间达到800h,可以明显观察到大量的Sn。从实验中可以得知,焊料中的Sn会随着电应力的作用开始发生迁移,且Sn是从焊点迁移到Si芯一侧。
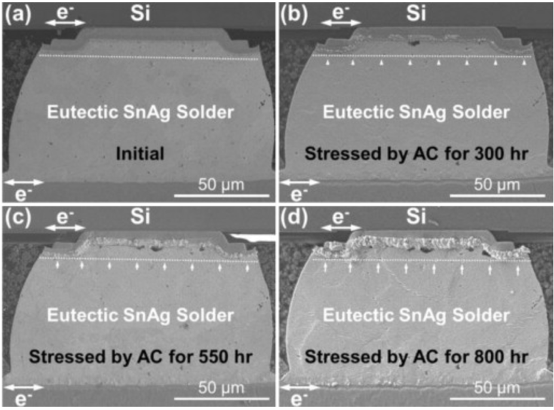
图2. 热梯度2829℃/cm的热迁移。(a)0h; (b)300h; (c)550h; (d)800h。
福英达有着多年的锡膏开发和销售经验,能为客户提供各种定制化的锡膏产品,如SAC305和SnBi57.6Ag0.4等。此外,福英达能为客户提供半导体焊接焊料解决方案,如优化回流曲线和焊接工艺。欢迎与我们联系合作。
Chen, C., Hsiao, H.Y., Chang, Y.W., Ouyang, F. & Tu, K.N. (2012). Thermomigration in solder joints. Materials Science and Engineering: R: Reports, vol.73.









 返回列表
返回列表



