BGA焊点金脆化问题-深圳市福英达

BGA焊点金脆化问题
金脆化是一种焊接缺陷,指的是焊点中含有过多的金属间化合物(IMC),导致焊点的脆性增加,可靠性降低。金脆化主要出现在BGA焊点的两个位置,即BGA本体与锡球间和焊锡膏与沉金板焊盘间。而BGA焊点金脆化可细分为两类,一是由热量不充足引起的金脆化,二是金含量过高引起的金脆化。
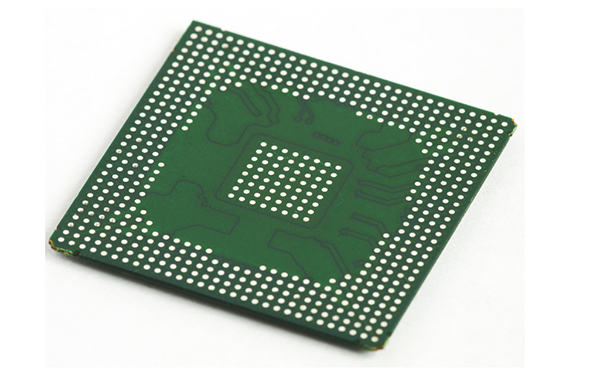
PCBA焊接过程中热量不足,PCB沉金层的金属会进入液态焊锡内,形成AuSn4堆积在焊点的金属间化合物(IMC)附近,导致焊点产生金脆化现象。这种金脆化问题可以通过调整PCBA的焊接工艺条件来改善,例如增加焊接温度和延长焊接时间,确保焊点内的金属能够充分熔化和扩散。
金含量过高引起的金脆化
另一类金脆化问题是由BGA焊点内金含量超过一定比例引起的。当焊点内金含量超过3%wt甚至5%wt以上时,金属间化合物的形成速率增加,导致焊点金脆化。这种金脆化无法通过调整reflow焊接温度曲线来解决,而是需要采取其他措施。为降低焊点内金含量,可以控制金层的厚度或增加焊锡量,使得焊点内的金含量维持在合适的范围内。
就PCBA工艺来讲,化学镍金厚度有限,不至于导致焊点内金含量超标,更多时候是金层扩散不完全导致的金脆化。如果金层扩散不完整,即使化学镍金厚度合适,仍有可能出现金脆化问题。因此,对于PCBA工艺,确保金层的扩散均匀和完整也至关重要。
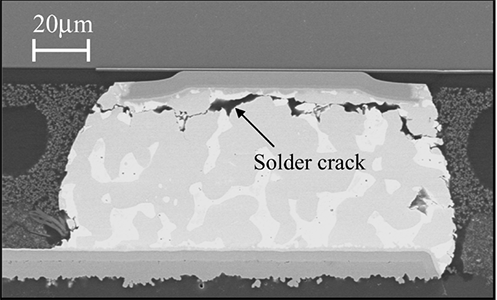
总之,BGA焊点金脆化问题是一项需要认真对待的焊接缺陷,它对电子产品的可靠性和性能产生不可忽视的影响。我们必须认识到,金脆化主要涉及两个方面:热量不充足和金含量过高。解决这些问题需要采取综合措施,包括优化焊接工艺参数、控制金层厚度以及适当调整焊接温度和时间。
在实际生产中,厂商应严格控制焊接工艺,确保焊接温度和时间能够使焊点内的金属充分熔化和扩散,避免金脆化的产生。此外,对于BGA封装设计,合理设置焊点的布局和结构,避免焊点受应力集中,也是减少金脆化的关键。
同时,科学合理地选择PCBA材料和工艺,控制金层的扩散均匀和完整,将是解决金脆化问题的重要方向。对于焊点内金含量过高的情况,可以通过控制金层厚度和增加焊锡量等方式,维持金含量在合适范围内,从而降低金脆化的风险。









 返回列表
返回列表



