使用温度对金锡焊点的影响-深圳福英达

使用温度对金锡焊点的影响-深圳福英达
在最近几十年对可靠的高温电子设备的需求迅速增长,主要集中在航空航天,功率电器,军工设备等应用。这些高温电子设备的使用对焊点的强度和稳定性的有着极高的要求。碳化硅(SiC)是一种适应高温的材料,通常被认为是首选的高温应用半导体。Au-Sn固液互扩散(SLID)是一种能用于高温键合的技术。该技术往往会用到共晶金锡锡膏,金锡锡膏能够将芯片与基板在280℃或更高的温度键合且焊点可靠性高。然而电子设备的使用温度通常会对焊点带来不同影响,因此金锡焊点的强度也需要进一步观察。
Tollefsen等人在室温,100°C,200°C和300°C下对四个Au-Sn SLID样本组进行剪切力测试,每个样本组包含六个样本。剪切力测试条件是在基板上方施加110μm测试高度和10μm/s的测试速度。
图1显示了芯片剪切强度和使用温度的关系。从图中可以看出剪切强度与使用温度呈现负相关关系。当使用温度在100℃以下时,芯片剪切强度随温度升高下降幅度较小,从约140 MPa下降到约130 MPa。这是由于增加的热能会在一定程度上降低化学结合能并导致芯片焊点出现热软化。然而,当使用温度从100°C上升到200°C,芯片剪切强度显著降低至60 MPa左右。在300°C时剪切强度继续下降,降至20 MPa左右,低于室温下剪切强度的15%。

图1. 不同使用温度下Au-Sn SLID样品的芯片剪切强度。
下图显示了在室温和300°C下剪切测试的Au-Sn SLID样品断裂表面。可以发现随着温度的升高,断裂模式由粘结型Au/Ni和内聚型ζ相/SiC断裂转变为以内聚型ζ相断裂为主。这表明剪切强度的大幅度降低源于Au-Sn-SLID键的弱化。
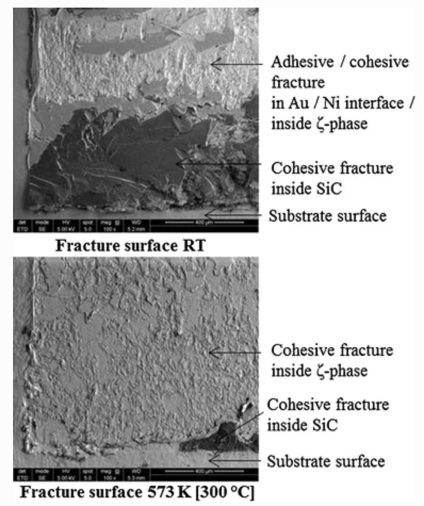
图2. 室温和300℃下Au-Sn SLID样品的断裂表面。
深圳市福英达有着专业的高温锡膏研发和生产经验,能够为客户提供优质的金锡锡膏用于高温焊接需求。福英达金锡锡膏有着粘度稳定,残留物少,焊点强度高等优点,欢迎客户与我们进行深入合作。
Tollefsen, T.A., Løvvik, O.M., Aasmundtveit, K. et al. (2013). Effect of Temperature on the Die Shear Strength of a Au-Sn SLID Bond. Metall Mater Trans A 44, 2914–2916.









 返回列表
返回列表



