芯片尺寸封装(CSP)类型-福英达锡膏

芯片尺寸封装(CSP)类型-福英达锡膏
为了实现集成电路芯片的电通路,一般需要将芯片装配到在塑料或陶瓷载体上,这一过程可以称为CSP。CSP的尺寸只是略大于芯片,通常封装尺寸不大于芯片面积的1.5倍或不大于芯片宽度或长度的 1.2 倍。体积要比QFP和BGA小数倍,因此能在电路板上实现更高的元器件安装密度。CSP还比QFP和PGA封装有着更高的硅占比(硅与封装面积的比例)。QFP的硅占比大约在10–60%,而CSP的单个芯片硅占比高达60–100%。
CSP和其他单片机封装形式类似,也是通过引线键合和倒装键合实现芯片与基板的互连。使用粘接剂将芯片与基板结合。CSP的封装结构类型有引线框架CSP, 刚性基板CSP,柔性基板CSP和晶圆级CSP。
引线框架CSP
引线框架CSP是一种常见CSP类型,可以实现无引脚封装。引线框架CSP需要用到引线键合技术将芯片与铜引线框架基板连接到一起。在完成键合后芯片会被塑料封装起来隔绝外界干扰。引线框架CSP的焊盘位于封装的外边缘,通过将CSP器件裸露的焊盘贴合到PCB焊盘的预涂覆锡膏上实现焊接安装。
引线框架CSP与普通塑料封装相比具有许多显着优势。由于封装尺寸与芯片尺寸很接近电路径得到进一步减小,因此改善了电气性能。无插装引脚使设备能够采用标准SMT设备进行贴装并使用锡膏焊接,更加节约了PCB的空间。
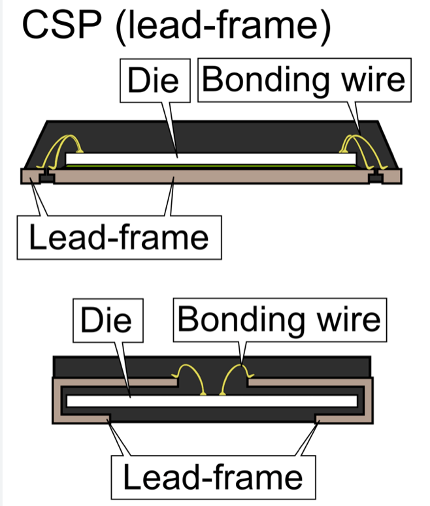
图1. 引线框架CSP结构。
刚性基板CSP和柔性基板CSP
刚性基板CSP采用的是陶瓷或塑料层压板作为基板材料,例如双马来酰亚胺三嗪(BT)。柔性基片CSP是一种市场领先的技术,其芯片基板是用柔性材料制成的,可以是塑料薄膜。柔性基板CSP使用具有焊料球或金属凸点的柔性电路作为芯片和下一层电路板之间的互连中介层。引线键合的柔性基板CSP在内存行业使用性很高。此外由于柔性基板能够提供更灵活的布线能力,因此非常适用于高I/O的逻辑设备。
晶圆级CSP
晶圆级CSP顾名思义可以理解为在晶圆的时候就完成批量封装,可以降低成本并提高产量。 在CSP的制造过程中需要重布 I/O 焊盘,涂覆聚合物薄膜,进行UBM制备和植球形成凸点。 然后制备了凸点的单个芯片会被封装,在测试完成后被切割出来。重布焊盘是为了满足焊料球的间距及排布要求。在重布焊盘和制备凸点时,能够使用与制造IC的光刻工艺类似的光刻工艺。晶圆级CSP能应用在很多半导体设备,包括电源管理,闪存/EEPROM,集成无源网络以及汽车电子元件。
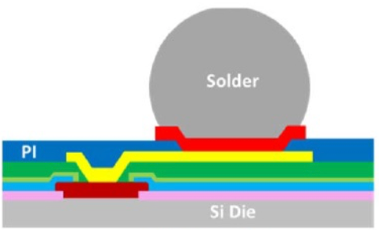
图2. 晶圆级CSP结构。
深圳市福英达能够提供半导体焊接用的锡膏产品,能够用于集成电路芯片倒装焊接和元器件表面贴装等工艺。此外锡膏还能够取代植球制备凸点。









 返回列表
返回列表



