先进封装的散热材料有哪些?-深圳福英达

先进封装的散热材料有哪些?
先进封装中的散热材料主要包括高导热陶瓷材料、碳基高导热材料、液态金属散热材料、相变材料(PCM)、新型复合材料等,以下是一些主要的先进封装散热材料及其特点:
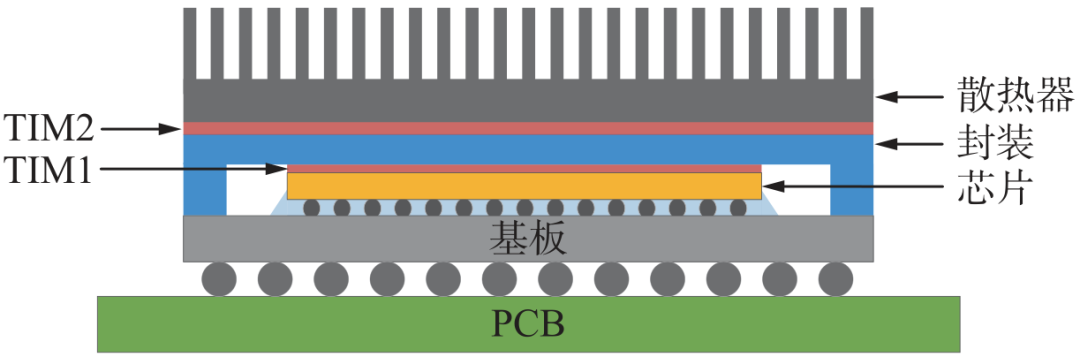
一、高导热陶瓷材料
氮化铝(AlN)和氮化硅(Si₃N₄):这些陶瓷材料的热导率可达100~200 W/(m·K),并且具备优异的机械强度和电绝缘性,成为功率电子封装的首选。例如,在电动汽车的SiC功率模块中,氮化硅AMB(活性金属钎焊)基板已广泛用于提升散热性能。
二、碳基高导热材料
石墨烯:理论热导率高达5000 W/(m·K),比铜高出十倍。但由于制备难度大,目前主要用于导热填料、涂层和复合材料。人工合成的高取向热解石墨(HOPG)也具有极高的面内热导率(>1500 W/(m·K)),在智能手机、笔记本电脑等消费电子散热领域得到广泛应用。
碳纳米管(CNT)和钻石复合材料:也在研究中。例如,美国半导体公司CVD Diamond开发的金刚石基板,热导率可达2000 W/(m·K),适用于射频功率器件的散热优化。
三、液态金属散热材料
镓基合金:因其超高的热导率(>30 W/(m·K))和极低的界面热阻,成为高端散热应用的突破性方案。例如,英特尔和AMD已在高性能处理器上应用液态金属导热界面材料(TIM),相比传统硅脂导热效率提高3~5倍,有效降低核心温度。此外,液态金属还可用于微流道冷却系统,使冷却液直接接触芯片,提高散热效率。
四、相变材料(PCM)
相变材料通过吸收和释放潜热来调节温度,适用于短时高功率脉冲散热。例如,某些石蜡基PCM可在50~100°C范围内熔化并吸收大量热量,避免芯片温度骤升,在5G基站、激光器等高脉冲功率设备中有较大应用潜力。
五、新型复合材料
金刚石/铜复合材料:结合了金刚石的高热导率和铜的适配热膨胀系数及加工成型性,成为新一代极具发展潜力的热管理材料。中国厂商通过界面金属化工艺突破,金刚石铜热导率稳定达600~800 W/(m·K),成本较进口低30%~40%,逐步切入华为、比亚迪等高端供应链。
碳化硅材料:导热性能优异,有望在中介层、散热基板等环节应用。例如,英伟达计划在新一代GPU芯片的先进封装环节中采用碳化硅衬底作为中介层材料,以优化整体封装尺寸并提高散热性能。台积电也正计划将12英寸单晶碳化硅应用于散热载板,取代传统的氧化铝、蓝宝石基板或陶瓷基板。
六、福英达的创新贡献
液态金属导热膏:液态金属是一大类多金属合金功能材料,在常温、常压下呈液体状态,可流动,具有沸点高、导电性强、热导率高等特点。其制造工艺不需要高温冶炼,环保无毒,主要应用在消费电子与精密结构件,高效热管理场景,增材制造与印刷电子,生物医疗,能源与化工,汽车与机器人等领域。
高导热焊锡膏:福英达研发的高导热焊锡膏采用特殊配方,兼具优异的导热性能和焊接可靠性。该材料可高效将芯片产生的热量传导至散热基板,降低工作温度,延长设备寿命。例如,在高性能AI芯片封装中,福英达的高导热焊锡膏通过优化合金成分和颗粒尺寸,显著提升了焊点的导热效率和机械强度。
定制化散热解决方案:福英达还提供定制化的散热材料服务,根据客户的具体需求和封装结构,开发符合其要求的散热材料。这种服务模式能够更好地满足客户的个性化需求,提高散热解决方案的针对性和有效性。例如,在激光器贴片封装中,福英达通过优化金锡合金焊料的成分和工艺参数,实现了高强度、高可靠性的焊接效果。
-未完待续-
*免责声明:本文由作者原创。文章内容系作者个人观点,转载仅为了传达一种不同的观点,不代表对该观点赞同或支持,如有侵权,欢迎联系我们删除!除了“转载”文章,本站所刊原创内容著作权属于深圳福英达,未经本站同意授权,不得重制、转载、引用、变更或出版。









 返回列表
返回列表



